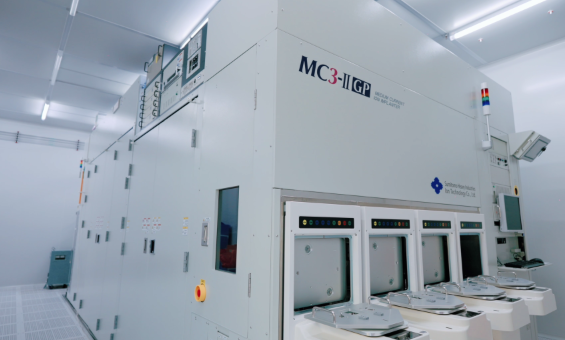
加工设备覆盖光刻(电子束/KrF深紫外/双面光刻)、薄膜沉积(磁控溅射/电子束蒸发/LPCVD)、刻蚀(深硅/离子束/湿法刻蚀)等核心工艺,并配备晶圆键合、引线键合(WB)及铜镍电镀系统,辅以离子注入、氧化扩散、CMP抛光等设备,形成从纳米级图形加工到晶圆级封装的全流程能力,支持硅基、玻璃、III-V族化合物及有机材料微纳器件制造。

封装工艺覆盖晶圆键合(支持阳极、共晶、热压键合等)、大压力芯片键合机(支持焊球直径40-450μm)、砂轮切片与半导体材料减薄(陶瓷/硅片/金属)、微组装贴片及倒装芯片键合、金线/铝线引线键合等核心环节,同时兼容3D IC封装、光电芯片耦合等特殊工艺。

表征与测试设备可实现在线/离线加工工艺的监控及表征,以及光/电性能表征。主要包含表面形貌量测(AFM、SEM、激光共聚焦显微镜等),薄膜厚度量测(椭偏仪、紫外干涉膜厚仪、台阶仪等),薄膜性能表征(紫外可见分光光度计、薄膜应力仪、高分辨X射线衍射仪、四探针薄膜电阻测量仪、电化学CV掺杂浓度测量仪、表面缺陷分析仪等),及器件与芯片电/光性能测量(半导体参数分析仪、霍尔效应仪、光电测试系统等)。