| 型号: | LH2 |
|---|---|
| 功能: | 1.在工艺温度630度左右进行高品质多晶硅沉积(工艺气体为硅烷); 2;在工艺温度540度左右进行高品质非晶硅沉积 |
| 工程师: | 李老师 / (021) 34206126-6015 / lijinxi@1 |
| 设备地点: | 西区高温炉管区 |
| 设备编号: | WDFSLPF01 |
多晶硅沉积设备主要用于LPCVD方式沉积多晶硅或者非晶硅薄膜, 通过LPCVD方式沉积的多晶硅薄膜具备高品质特点,是微纳加工领域重要的薄膜沉积设备, 尤其在硅基的CMOS工艺中具备重要的作用。
多晶硅沉积设备主要用于LPCVD方式沉积多晶硅或者非晶硅薄膜, 通过LPCVD方式沉积的多晶硅薄膜或者非晶硅薄膜,品质高,工艺温度为600度左右, 厚度可以从30纳米到400纳米左右,薄膜均匀度可以做到3%以内。
多晶硅沉积设备主要用于LPCVD方式沉积多晶硅或者非晶硅薄膜, 通过LPCVD方式沉积的多晶硅薄膜或者非晶硅薄膜,样品尺寸为6英寸以下圆片。
通过LPCVD方式,由硅烷分解生成多晶硅薄膜,沉积与硅衬底之上。

CMOS工艺中多晶硅薄膜沉积。
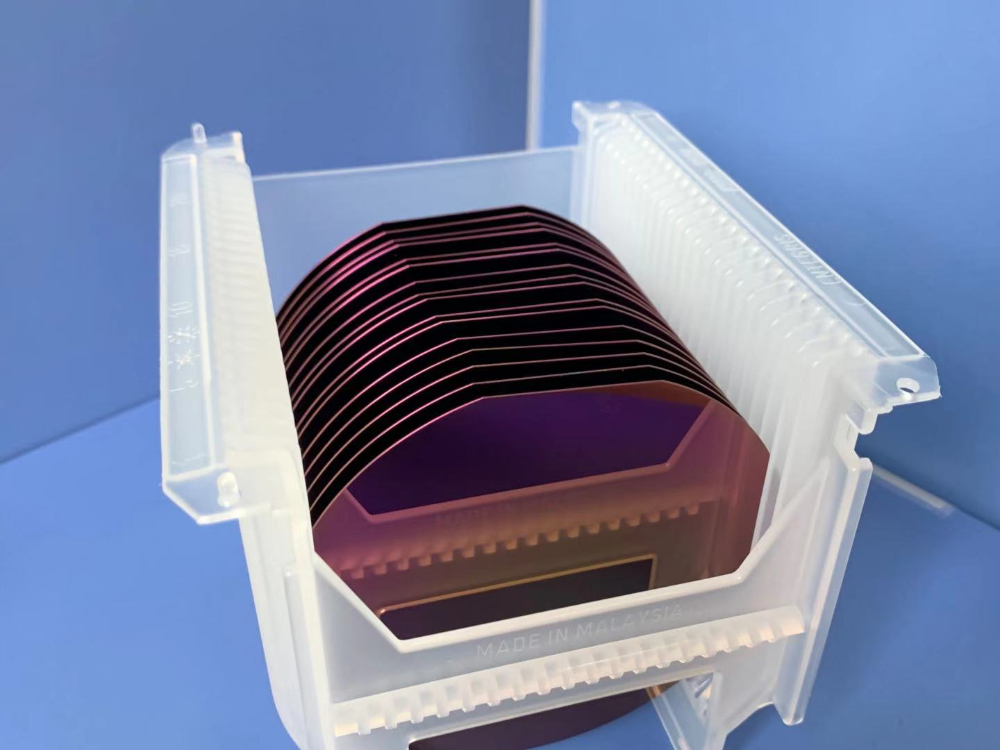
只有3~6寸硅片(圆片)才可以作业;禁止后道硅片进入。
600度左右。