| 型号: | ICP180 |
|---|---|
| 功能: | 低温(300℃)氧化硅、氮化硅、非晶硅、氮氧化硅、碳化硅等薄膜沉积 |
| 工程师: | 刘老师 / (021) 34206126-6013 / minliu@1 |
| 设备地点: | 西区薄膜II区 |
| 设备编号: | WF2OCVD01 |
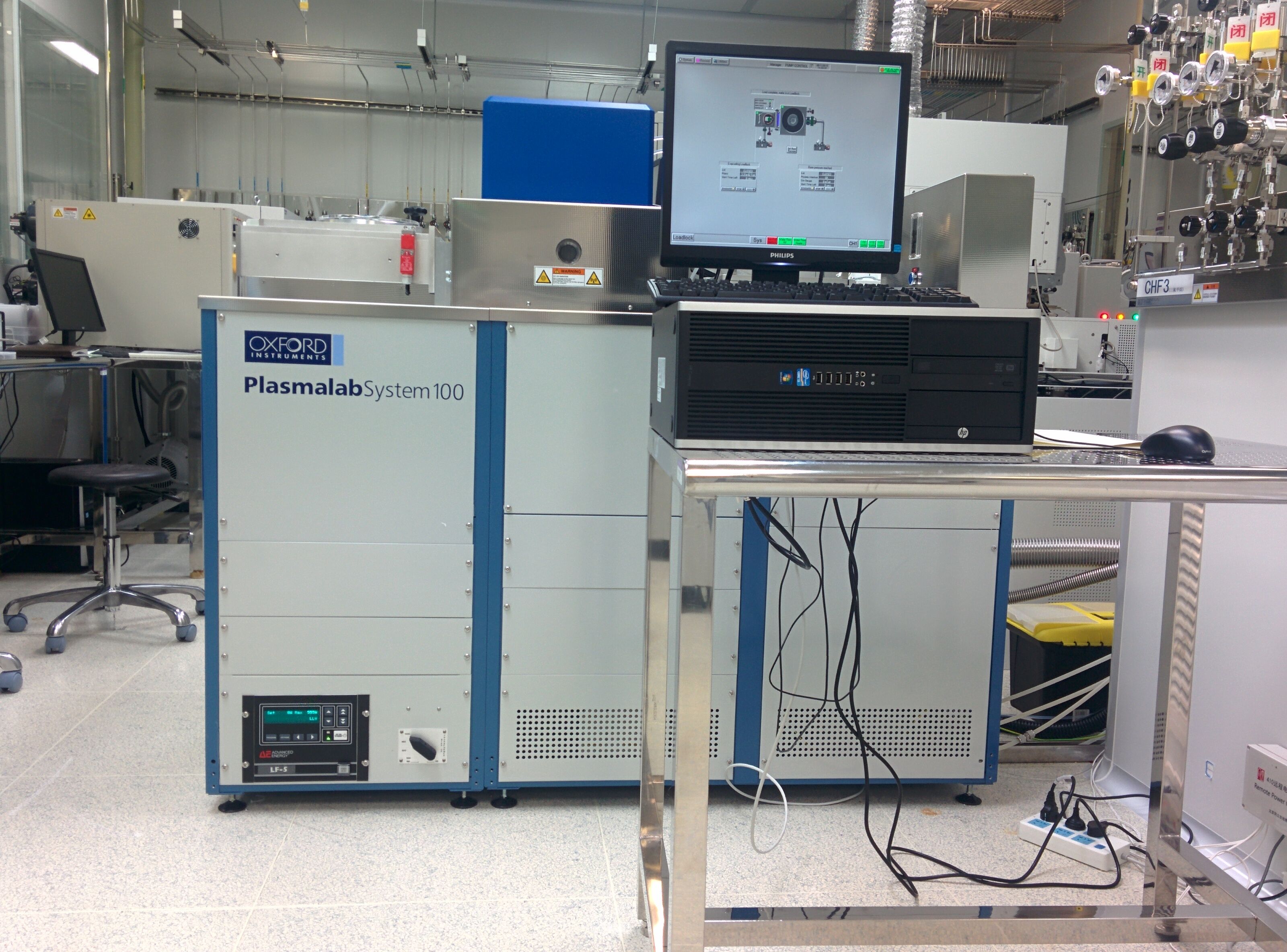
利用射频使含有薄膜组成原子的气体电离,在局部形成等离子体,促进气体系列化学反应,在样品表面形成固态薄膜。主要用于SiOx, SiNx, a Si等低温条件下的薄膜生长。

PECVD技术是在低气压下,利用低温等离子体在工艺腔体的阴极上(即样品放置的托盘)产生辉光放电,利用辉光放电(或另加发热体)使样品升温到预定的温度,然后通入适量的工艺气体,这些气体经一系列化学反应和等离子体反应,最终在样品表面形成固态薄膜。其工艺原理示意图如图所示。
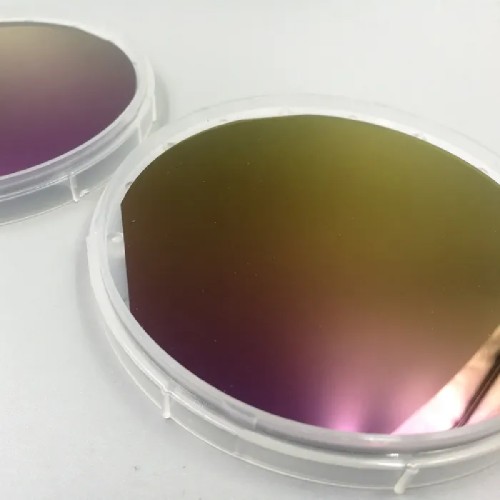
图为在4英寸LNOI片上沉积500nm非晶硅(a Si)薄膜。
PECVD为高温制程(~400度),不接受耐高温性差的样品(如含光刻胶的样品),不接受带污染的样品。
不可以,设备正常工艺温度为300℃,不能用于耐热性差的样品。