| 型号: | DSE200s |
|---|---|
| 功能: | 1. BOSH工艺或非BOSH工艺深硅刻蚀; 2. TSV(硅通孔)工艺硅深孔刻蚀; 3. SOI表面硅结构刻蚀。 |
| 工程师: | 刘老师 / (021) 34206126-6013 / minliu@1 |
| 设备地点: | 西区薄膜II区 |
| 设备编号: | WF2NDSE02 |
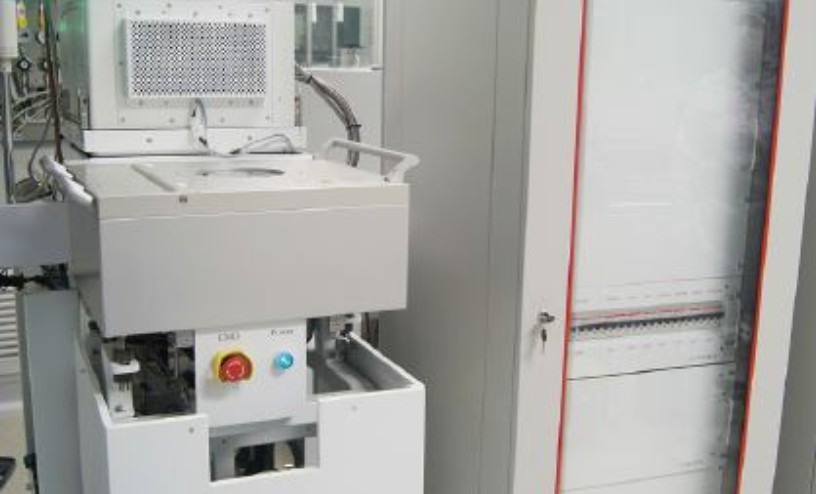
主要用于深硅刻蚀,同时兼具Bosch/Non-Bosch工艺,实现多工艺领域覆盖。该机台针对Bosch循环工艺方式采用专业先进的快速响应硬件配置及软件流程控制,结合先进的工艺技术,可实现高深宽比下良好的工艺性能,满足各种工艺需求。
最大刻蚀速率约6um/min,与光刻胶选择比高达50:1,深宽比>30:1,侧壁粗糙度<50nm。
机台为六英寸设计,可向下兼容4、3英寸和各种不规则硅片,破片等,也可用于玻璃基底的SOG片等。
Bosch工艺是指在集成电路制造中为了阻止或减弱侧向刻蚀,设法在刻蚀的侧向边壁沉积一层刻蚀薄膜的工艺。因最早由Robert Bosch提出,亦被称为Bosch工艺。
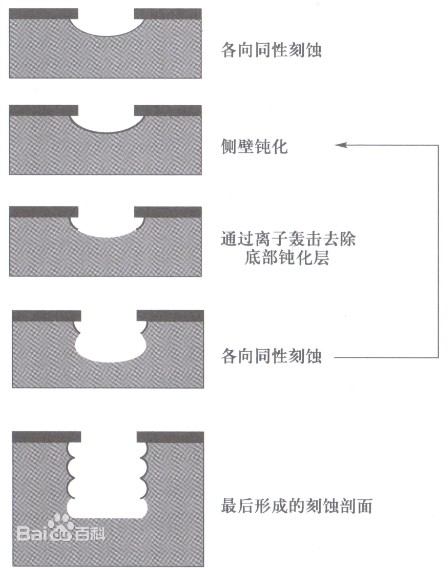
图为应用于MEMS器件制作中的深硅刻蚀工艺。
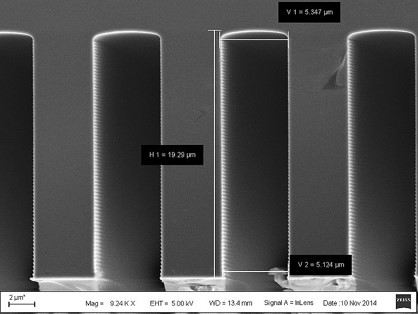
该设备以深硅刻蚀工艺为主,不接受大于6英寸样品;如果样品为非6寸片或碎片,需要用粘片方式刻蚀;
可接受的掩膜材料为光刻胶,二氧化硅、氮化硅等硬掩模,不接受金属掩膜。