| 型号: | µGALV |
|---|---|
| 功能: | 电镀铜 |
| 工程师: | 田老师 / (021) 34206126-6031 / miaotian@1 |
| 设备地点: | 东区电镀区 |
| 设备编号: | EPL0CUP01 |
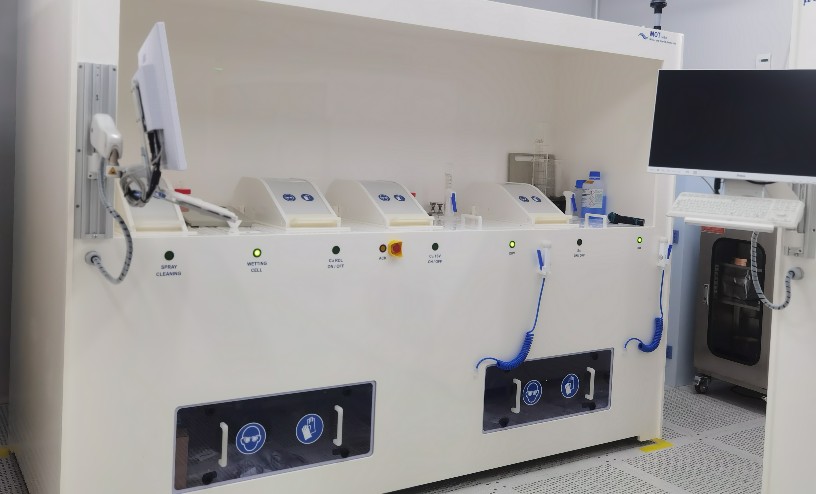
此设备主要用于铜电镀。电镀铜有良好的导电性、稳定性和延展性且孔隙率低。被广泛应用于半导体互连工艺。同时也是广泛使用的一种预镀层,可用于改善镀层结合力。
铜电镀是一种利用电化学方法在基体表面沉积铜层的工艺。其电镀液有硫酸铜、导电盐、pH调节剂等组成。电镀过程中将基体作为阴极,通电后,铜离子在阴极表面还原析出,形成铜镀层。
微凸点工艺:
(1)光刻胶厚度 20um,形成孔径40um
(2)电镀10-15um铜,再电镀5-10um锡
样品尺寸小于6英寸。需要有Cu种子层。异形样品会增加工艺时间,提前与工艺工程师沟通。
最好是300nm以上的铜。