| 型号: | 3030EX6 |
|---|---|
| 功能: | 180 nm半导体工艺节点光刻工艺 |
| 工程师: | 徐老师 / (021) 34206126-6018 / xu.jian@1 |
| 设备地点: | 东区光刻II区(Canon) |
| 设备编号: | ELT2DUV01 |

用于将掩模版上的芯片电路图转移到硅片上,是IC制造的核心环节。光刻机的基本工作原理是利用光学原理将图案投射到硅片上。它主要由光源、凸透镜、光刻胶和控制系统等组成。本设备主要用于0.18 um半导体工艺技术节点中实现全自动对准光刻。
设备光路结构图
该装置采用 248 nm准分子激光作为光源,将最小工艺节点提升至 180nm 水平。在曝光工艺上采用了步进重复投影式光刻,光源通过掩模(reticle),经光学镜头调整和各种成像误差补偿后, 将掩模上的电路信息以缩微成像的方式投射至晶圆上,同时高精度工件台以步进重复的方式承载着硅片运动,实现die by die的连续曝光,直至整个晶圆铺满掩模图形,设备精度高且曝光速度极快,且整个曝光过程全自动执行无需人为干预。
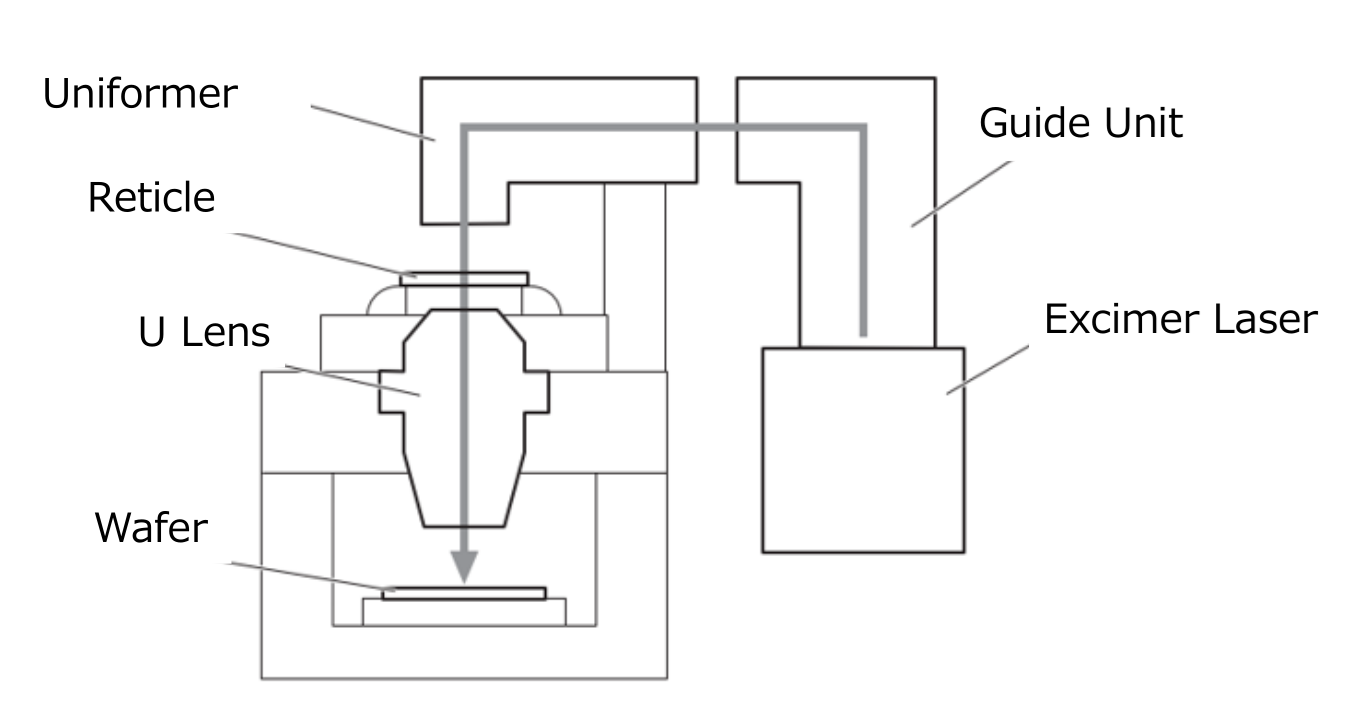
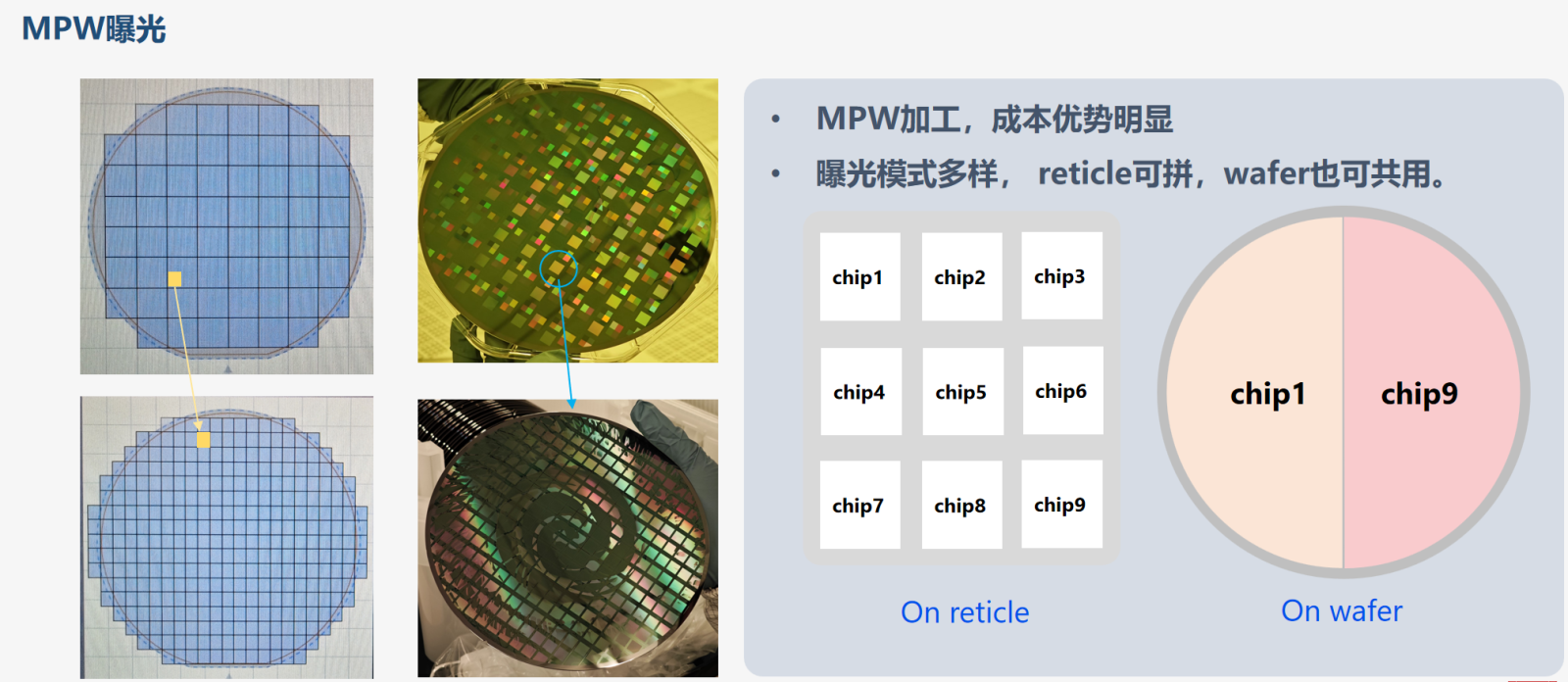

按需分时间段,分别进行8寸、6寸、4寸、3寸全自动涂胶-曝光-显影。
目前使用UV135g ,400nm 厚度