| 型号: | Auriga |
|---|---|
| 功能: | 在微纳米尺度下对样品进行图形化沉积、切割、刻蚀的二维及三维结构加工 |
| 工程师: | 王老师 / (021) 34207734-8006 / wangying@1 |
| 设备地点: | 西区薄膜IA区 |
| 设备编号: | WF1ZFIB01 |
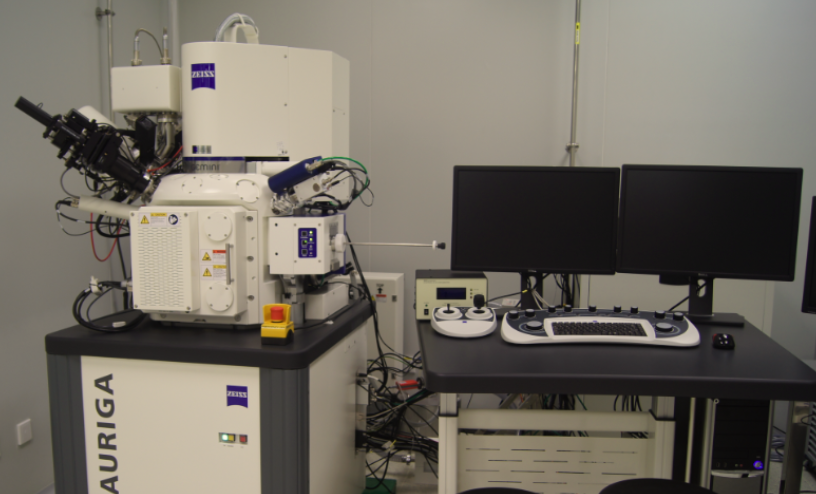
双束系统中场发射扫描电镜主要用于观察、分析材料的微观形貌,聚焦离子束用来对样品进行在微纳米尺度下的图形沉积、切割、刻蚀、透射样品制备、电路修复及原子探针针尖加工等工作。
1.Pt,W,C,SiO2,XeF2气体注入系统:可在离子束、电子束诱导下进行可控沉积及增强或选择性刻蚀。
2.牛津纳米机械手(含电学性能测试):透射电镜取样系统,可提取FIB切割后的微小样品,配合FIB对纳米材料进行搬运、操纵。
3.三维成像系统:可实现对样品的自动切割,自动拍照以及所有照片叠加后的三维重构。
4.微纳米加工系统:具备离子束沉积并加工复杂图形的软硬件系统。
5.具有电子束流枪,可对绝缘体材料无干扰加工或刻蚀。
6.最大样品尺寸不大于150mm;极限真空:优于5×10-7Torr。
聚焦离子束(FIB)技术,其核心原理在于电场与磁场的协同作用,使得离子束能够聚焦至亚微米乃至纳米尺度。通过精确操控偏转与加速系统,控制离子束的扫描路径,从而实现微纳尺度图形的精确分析和无掩模加工。该技术是一种利用高强度聚焦离子束对材料进行微纳尺度加工的方法。FIB技术能够实现对样品的精确切割,并通过观察其横截面来揭示其形貌和尺寸特性。此外,该技术可与元素分析(如EDS)等技术相结合,以分析表面及截面成分。同时FIB技术还具备材料剥离、沉积、注入及改性等多项功能。
沉积与刻蚀
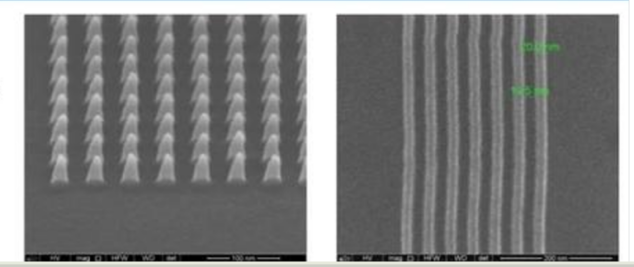
截面观察
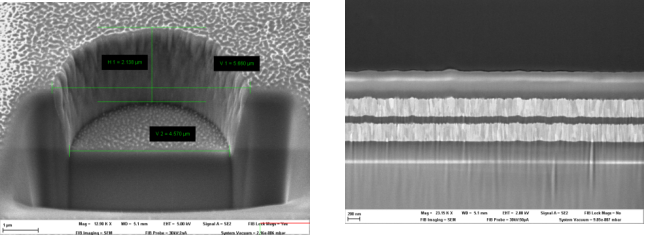
电路修复及三维加工
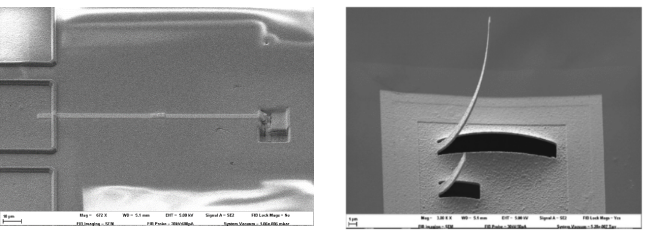
禁止磁性及粉末样品,样品保持洁净,禁止用手直接触摸。大小最好不超过2x2cm.
采用聚焦离子束(FIB)对样品表面进行微细切割,切割厚度约2纳米。同时利用扫描电子显微镜(SEM)对样品进行成像。通过反复执行上述切割与成像步骤,并结合计算机图像处理技术,获得样品的三维空间结构信息。
利用离子束撞击样品表面,或搭配有机气体对样品进行有效的选择性蚀刻(切断电路)、沉积金属或介质材料(新接电路)。
样品是在电子束或离子束下进行操作,需要清晰观察到样品形貌,否则无法精准制样。
A、样品加工位置要靠近边缘
B、样品导电与否,导电性较差试样应进行喷金处理