| 型号: | SB² Jet |
|---|---|
| 功能: | 设备用于在芯片、各类基板、晶圆等器件的焊盘上进行选择性激光植球或者阵列微凸点加工。 |
| 工程师: | 刘老师 / 34206126-6027 / liudanqh@1 |
| 设备地点: | 东区封装II区 |
| 设备编号: | EPK2LSJ01 |
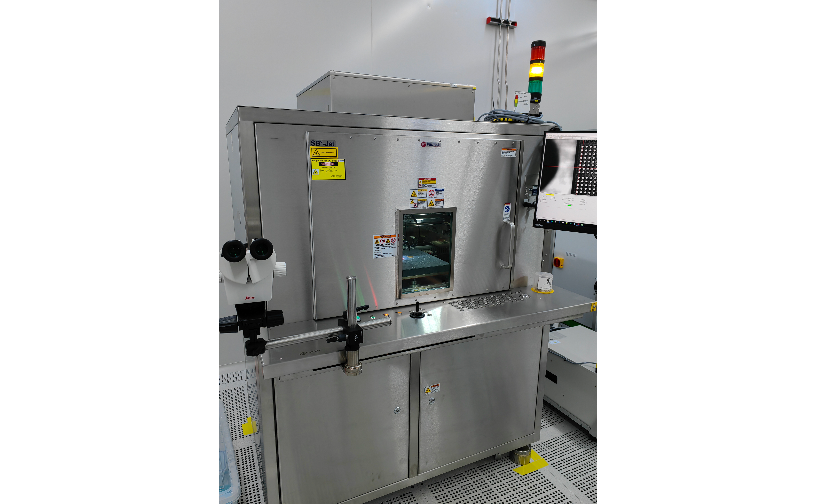
激光植球机用于在单芯片、各类基板、晶圆、BGA等半导体或微电子器件的焊盘上进行选择性激光植球或者阵列微凸点加工,特别适用于单芯片倒装凸点的制作和窄节距焊球的植球。
激光植球机适用于40μm-450μm范围的焊球直径,适用于各种常见合金的焊球,可实现非接触式焊接。
激光植球就是采用激光熔化焊球并喷射到对应焊盘上来形成凸点的方法。单颗焊球首先通过分球系统输送到喷嘴,在激光的作用下加热熔化并在氮气流的作用下喷射至焊盘表面,完成锡球的浸润焊接。
倒装芯片凸点(图片来源于设备网站宣传图)

100μm SAC焊球
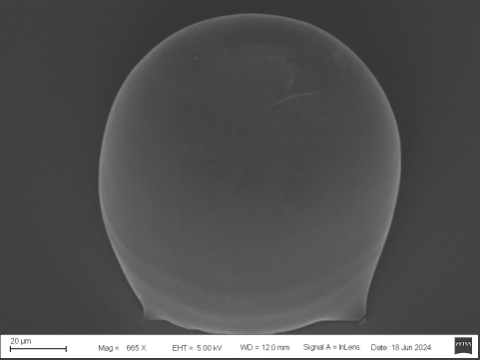
450μm SAC焊球
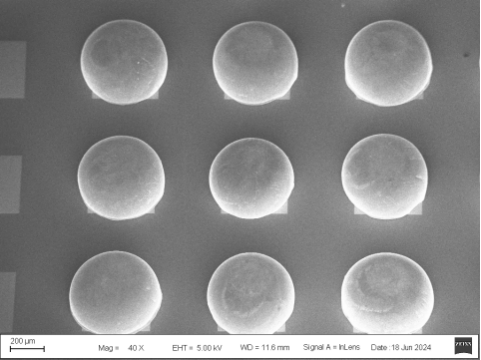
样品焊盘表面须与植球焊料可浸润,焊盘表面洁净。
主要表现为焊球从焊盘表面飞走或位置偏移,一般为焊盘金属与焊球之间浸润不好或焊盘表面不洁净。