| 型号: | 150 |
|---|---|
| 功能: | 支持各类芯片的冷压、热压回流、共晶工艺。设备具备倒装焊及正装焊功能,可实现芯片-芯片/芯片-晶圆等键合方式。 |
| 工程师: | 刘老师 / 34206126-6027 / liudanqh@1 |
| 设备地点: | 东区封装II区 |
| 设备编号: | EPK2FCB01 |
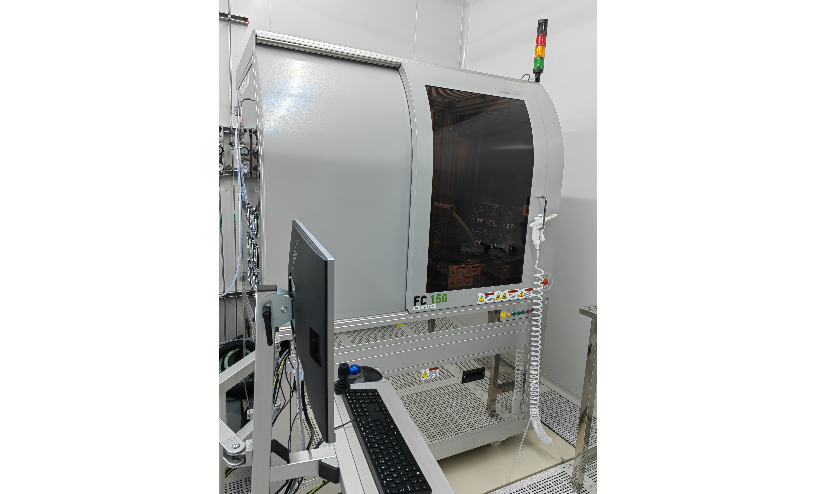
大压力芯片键合机具有芯片的精细平行度调整能力、大的键合压力和更高的键合精度,使其在光电及光子器件组装、焦平面器件、3D集成等领域具有广泛的应用。
倒装焊技术是将芯片朝下通过凸点互连到基板、晶圆或者电路板上,形成稳定可靠的机械和电气连接。设备通过对芯片进行调平、对准和接合,具备芯片电极面朝下经钎焊、热压等工艺实现芯片凸点和封装基板互连的功能。
焦平面阵列(图片来源于设备网站宣传图)

图像传感器(图片来源于设备网站宣传图)
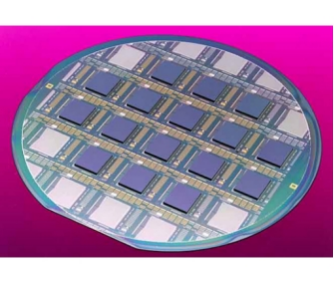
射频领域(图片来源于设备网站宣传图)
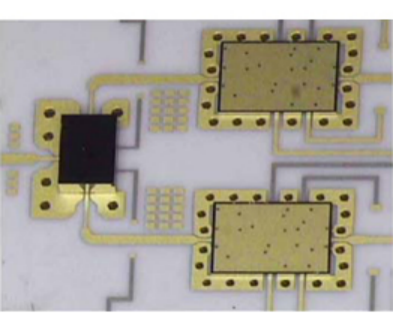
射频器件(图片来源于设备网站宣传图)
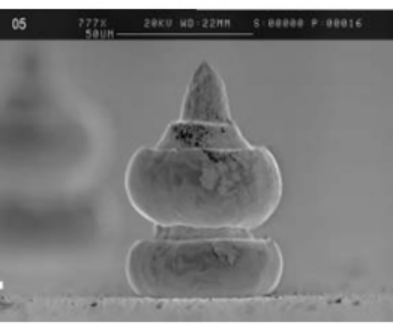
样品正面和背面均需要保持洁净,尤其背面无沾污及颗粒物。
需要提前在样品上制作3个反光层区域,尺寸不小于50×50μm(一般为金属层,如Cr层等)。