| 型号: | ACCμRA OPTO |
|---|---|
| 功能: | 用于光电芯片、激光器芯片等的高精度倒装互连耦合工艺。支持各类芯片的冷压焊、回流焊、原位回流、无助焊剂共晶键合、热压键合等。 |
| 工程师: | 刘老师 / 34206126-6027 / liudanqh@1 |
| 设备地点: | 东区封装II区 |
| 设备编号: | EPK2EOC01 |
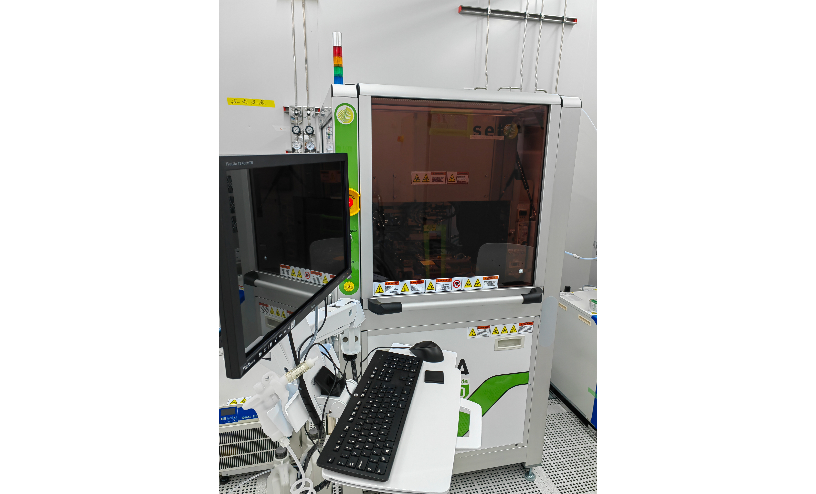
高精度光电芯片耦合系统专用于高精度的低压力键合和回流焊工艺,用于光电芯片、激光器芯片等的高精度倒装互连耦合工艺。
高精度光电芯片耦合系统采用固定分光镜的视觉对位系统,实现芯片与基板的精确视觉对准,从而实现高精度键合/焊接。
光电器件组装(图片来源于设备网站宣传图)

多芯片组件(图片来源于设备网站宣传图)

MEMS封装(图片来源于设备网站宣传图)
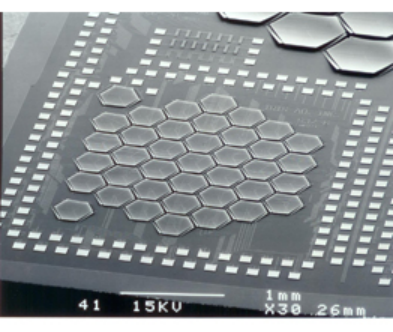
样品正面和背面均需要保持洁净,尤其背面无沾污及颗粒物。
一般建议芯片吸盘的真空区域占芯片总面积的50%及以上,避免因为真空吸附引起芯片翘曲从而影响最终键合效果。