| 型号: | TFS200 |
|---|---|
| 功能: | 具备热ALD和PE-ALD两种工作模式,即采用加热或等离子辅助沉积多种超薄高保形性、高台阶覆盖能力的介质薄膜材料,如金属氧化物,厚度可实现原子层的控制(1 atom-layer/cycle)。可沉积薄膜包括:氧化铝(Al2O3),氮化铝(AlN),氧化硅(SiO2),氧化铪(HfO2),氮化铪(Hf3N4),氧化钛(TiO2),氧化钽(Ta2O5),氮化钽(TaNx)。 |
| 工程师: | 乌李瑛 / (021) 34206126-6028 / lynn_wu@1 |
| 设备地点: | 西区薄膜IA区 |
| 设备编号: | WF1BALD01 |
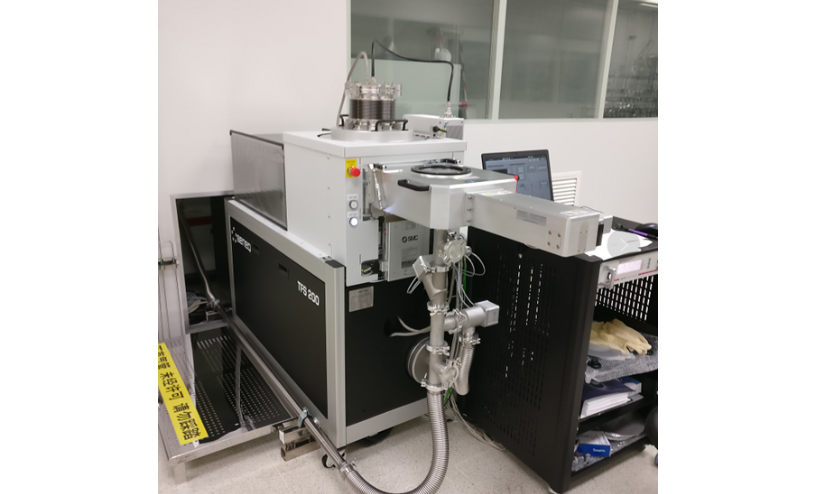
具备热ALD和PE-ALD两种工作模式,即采用加热或等离子辅助沉积多种超薄高保形性、高台阶覆盖能力的介质薄膜材料,如金属氧化物,厚度可实现原子层的控制(1 atom-layer/cycle)。
可沉积薄膜包括:氧化铝(Al2O3),氮化铝(AlN),氧化硅(SiO2),氧化铪(HfO2),氮化铪(Hf3N4),氧化钛(TiO2),氧化钽(Ta2O5),氮化钽(TaNx),氧化磷(POx),以及定制化的铁电HfZrO薄膜。
常规原子层沉积是通过将气相前驱体脉冲交替地通入反应器并在沉积基片上自限制式化学吸附并在一定温度下反应而形成单原子层沉积膜的一种方法。不断重复这种自限制反应就形成所需要厚度的薄膜。在膜层的均匀性、保形性、阶梯覆盖率以及厚度控制等方面都具有明显的优势。等离子体增强原子层沉积(PE-ALD)是对ALD技术的扩展,通过等离子体的引入,产生大量活性自由基,增强了前驱体物质的反应活性,从而拓展了ALD对前驱源的选择范围和应用要求,缩短了反应周期的时间,同时也降低了对样品沉积温度的要求,可以实现低温甚至常温沉积,特别适合于对温度敏感材料和柔性材料上的薄膜沉积。另外,等离子体的引入可以进一步的去除薄膜中的杂质,可以获得更低的电阻率和更高的薄膜致密度等。此外,等离子体还可以对反应腔室进行清洗以及对基片进行表面活化处理等。
ALD可实现绝缘栅介质(高介电常数)、钝化层介质、保护层介质、金属阻挡层介质等多种材料原位生长, 可实现高度保形性镀膜。同时可以沉积定制化的铁电HfZrO 薄膜。
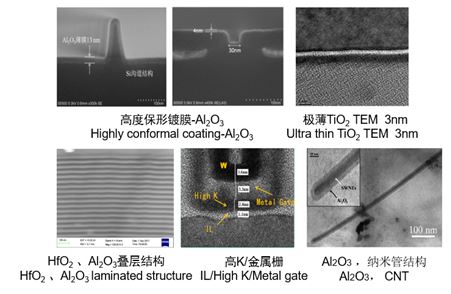
【PEALD送样须知】
样品尺寸小于8英寸,样品保持洁净,不接受粉末,不接受带污染的样品(如可挥发有机物,光刻胶等),请先和工程师沟通确认后再预约。
【PEALD收费细则】
①设备如沉积同一种材料,按照AEMD普通时长收费标准执行,该时长为样品从进机台算起,至样品工艺结束后传出机台结束。
②如需沉积不同材料体系(掺杂工艺),存在一定的工艺难度:
a)如果掺杂=2,现有成熟工艺按照普通时长收费(其中的材料费按材料占比大的算),该时长为样品从进机台算起,至样品工艺结束后传出机台结束
b)如果掺杂>2,工艺难度及设备风险加大,原则上不接受该类预约,如确实因课题需要且能提供所有工艺参数,除按照普通时长(a)收费外,需另收取人工费
③如需沉积不同材料体系(多层膜工艺),因工艺复杂(第二层膜沉积前,第一层膜工艺菜单需结束,关闭第一层膜材料的手阀并吹扫管路,同时,下载第二层膜工艺菜单到设备上,运行第二层膜工艺,开启第二层膜的手阀,以此类推),对设备而言相当于是重新开始一项工艺,原则上换沉积体系的材料都需要进行一项新的预约:
a)如果沉积层数=2,第一层正常收费,第二层沉积厚度低于等于5nm,考虑到样品未拿出设备,节省了样品传输时间,可酌情第二层只收取材料费,免除人工费、设备费;
b)如果沉积层数=2,第二层沉积厚度大于5nm,第二层需单独预约和单独结算,按普通时长收费标准执行;
c)如果沉积层数>2,每层都需单独预约和单独结算,按普通时长收费标准执行;
④因设备材料源位有限,如需沉积平台设备目前没有的材料体系(预约量大),需经评估对设备无风险,且需平台领导签字批准,源瓶、VCR垫片和源材料一律自行购置。
⑤长期的标准成熟工艺如失败需给出直接性证据经双方一致认可,方可退费;非标工艺具有研发性质,平台不承担失败的后果。
⑥工艺时长最小收费单位30分钟,不足30分钟按30分钟计费。
这台原子层沉积设备主要沉积绝缘介质薄膜,如果有金属薄膜沉积的需求,请预约平台网站的等离子辅助原子层沉积系统(金属)(设备编号:EFM4ALD01),其专门沉积金属薄膜。