| 型号: | EVG510 |
|---|---|
| 功能: | 1、将两个或多个晶圆进行紧密的连接,可实现多个晶圆之间的高密度互联,特别是在3D IC封装中具有广泛的应用; 2、可支持包括阳极键合、共晶键合、热压键合等多种晶圆键合工艺; 3、可配套EVG-610光刻机实现晶圆对准、定位功能; 4、前期可配套等离子体、湿法等工艺对于晶圆进行清洗 |
| 工程师: | 张老师 / 34206126-6029 / captianzhangdi@1 |
| 设备地点: | 东区光刻II区(Canon) |
| 设备编号: | ELT2WBS01 |
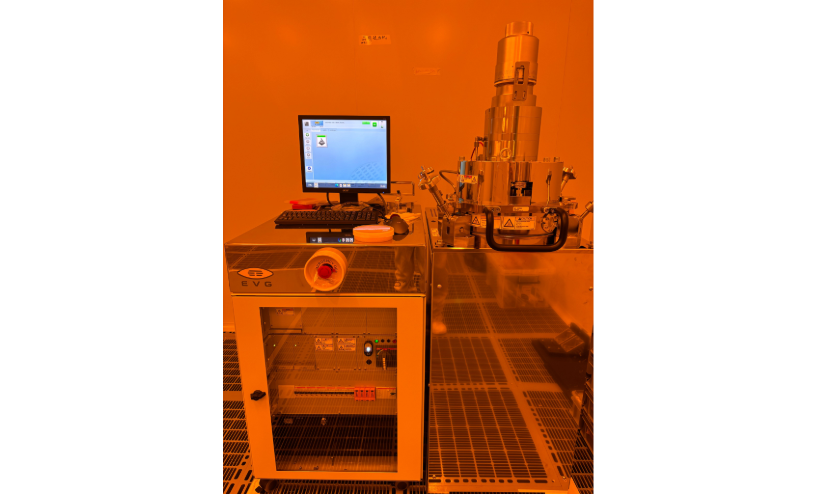
一款晶圆键合设备,通过热、压力和真空技术实现高精度晶圆键合。
光学对准:高精度对准系统使用显微镜和标记对齐晶圆,实现亚微米级精度。
压力控制:通过气压或机械加载施加均匀压力,确保晶圆紧密接触并消除空隙。
热处理:加热平台提供可控温度,用于激活键合材料或促进化学反应固化。
真空环境:真空腔体减少气泡生成,优化键合界面质量。
自动化工艺:支持升温、加压和冷却的全流程自动化控制,确保重复性和可靠性。 EVG510适用于硅-硅、硅-玻璃、各类金属等多种材料键合,广泛用于MEMS器件制造和晶圆级封装。
通过结合热、压力和真空技术,实现晶圆间的可靠键合,用于硅-硅、硅-玻璃、各类金属等多种材料的连接
阳极键合

1、样品需提前与工艺老师确认。
2、样品正面与背面均需要保持平整洁净。
3、共晶键合可适用包含及不限(Au-Sn、Au-Si、Al-Al、Al-Ge、Cu-Cu、Cu-Sn、Au-In)等
键合面积太小,电压太低