| 型号: | FIJI F200 |
|---|---|
| 功能: | 用于沉积超薄、均匀性好、高保形性的金属薄膜(如Cu、TiN,Ru等),适用于TSV等深沟槽器件 |
| 工程师: | 乌老师 / (021) 34206126-6028 / lynn_wu@1 |
| 设备地点: | 东区薄膜Ⅳ区 |
| 设备编号: | EFM4ALD01 |
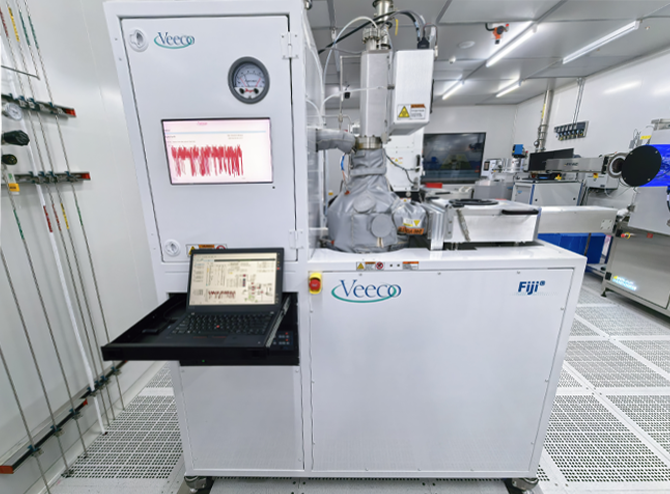
具有热法和等离子增强法两种沉积模式,主要用于沉积超薄、均匀性好、高保形性的金属薄膜(如Cu、TiN,Ru等)。
可采用ICP电感耦合等离子辅助技术,在低功率(不损坏衬底)下制备高质量金属薄膜,适用于TSV通孔及深沟槽器件的镀膜。
同时,本设备也可以沉积氧化物、氮化物介质薄膜(但这台设备因为考虑到交叉污染等原因主要用于沉积金属)。
原子层沉积是一种特殊的化学气相沉积技术,通过将气相前驱体交替地通入反应室,并在基底表面发生化学吸附和反应,形成原子级别的薄膜。
原子层沉积技术具有以下关键特性:
1. 自限制生长:每次反应只发生在单层原子上,确保薄膜的厚度和组成可控。
2. 优异的三维保型性:能够在复杂形状的基底上均匀沉积薄膜。
3. 大面积均匀性:能够在较大的基底面积上实现均匀的薄膜沉积。
4. 低温生长:适用于在低温下进行薄膜沉积,适用于某些敏感材料的处理。
硅片上用等离子增强原子层沉积工艺制备得到的厚度为40nm的TiN薄膜,其电阻率约80µὩcm,厚度均匀性偏差<3%
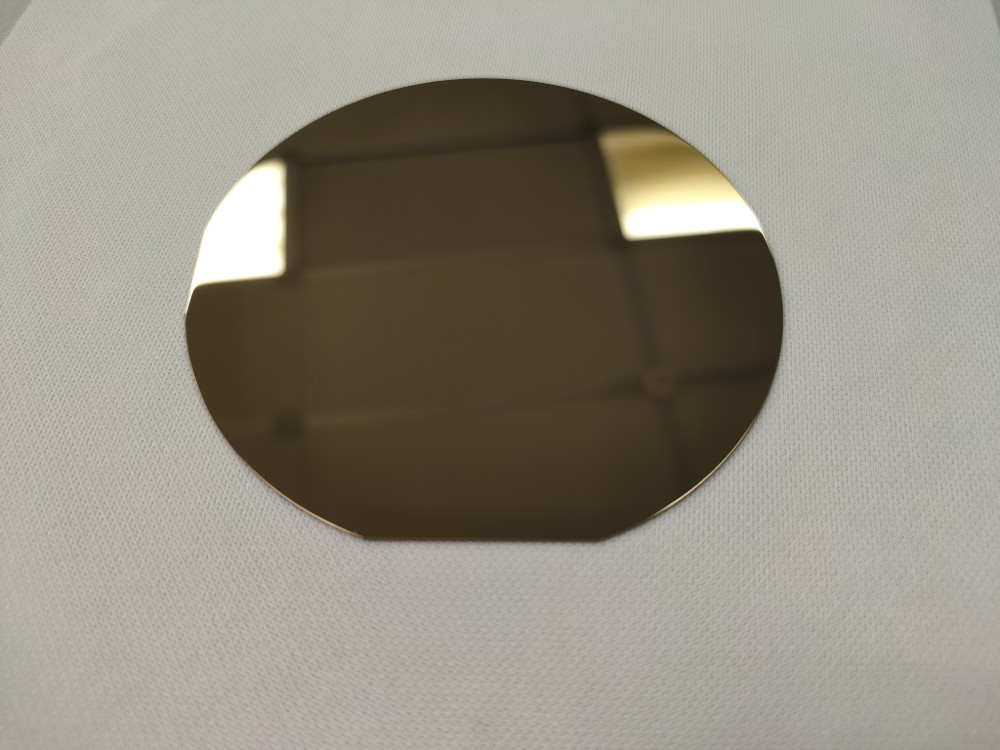
禁止粉末样品,样品表面干净,不可带胶沉积
量大可考虑,且需要自己购置源瓶和源材料
如对漏电要求低,本设备也可以沉积氧化铝、氮化铝