| 型号: | ICP-SR |
|---|---|
| 功能: | 1. BOSH工艺或非BOSH工艺深硅刻蚀; 2. TSV(硅通孔)工艺硅深孔刻蚀; 3. SOI表面硅结构刻蚀。 |
| 工程师: | 刘老师 / (021) 34206126-6013 / minliu@1 |
| 设备地点: | 西区薄膜II区 |
| 设备编号: | WF2SDSE01 |
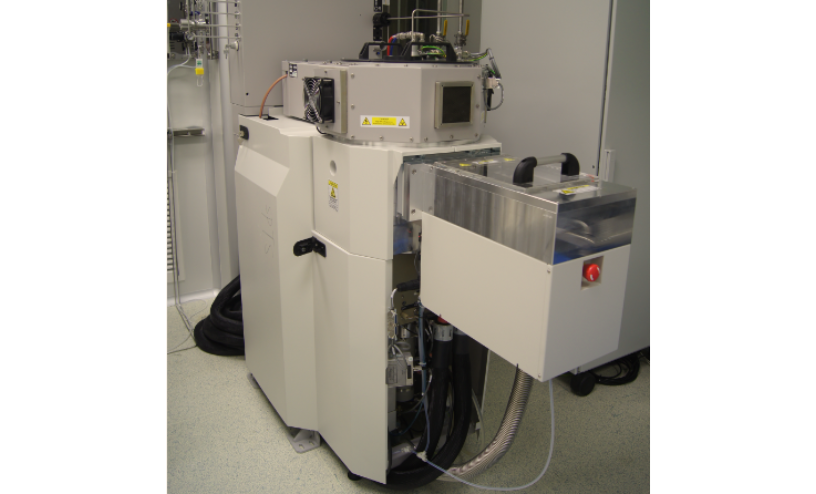
主要用于硅、SOI微纳米结构刻蚀,主要应用的工艺有硅波导、光栅等纳米级细微结构刻蚀,以及MEMS器件中硅的深刻蚀。
首先采用氟基活性基团进行硅的刻蚀,然后进行侧壁钝化,刻蚀和保护两步工艺交替进行。图说明了其工艺过程。它是通过交替转换刻蚀气体与钝化气体实现刻蚀与边壁钝化。其中刻蚀气体为SF6,钝化气体为C4F8。C4F8在等离子体中能够形成氟化碳类高分子聚合物。它沉积在硅表面能够阻止氟离子与硅的反应。刻蚀与钝化每5~10s 转换一个周期。在短时间的各向同性刻蚀之后即将刚刚刻蚀过的硅表面钝化。在深度方向由于有离子的物理溅射轰击,钝化膜可以保留下来,这样下一个周期的刻蚀就不会发生侧向刻蚀。通过这种周期性“刻蚀-钝化-刻蚀”,刻蚀只沿着深度方向进行。
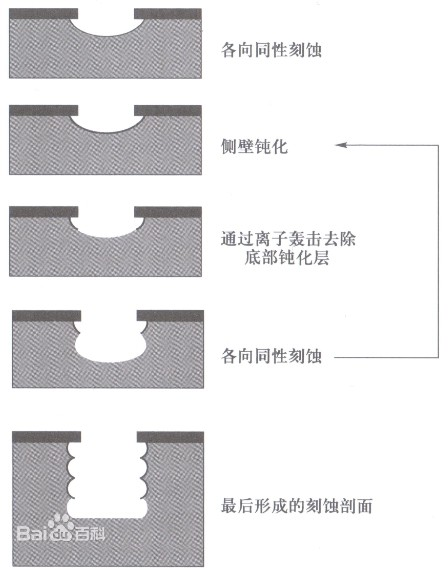
图为MEMS器件的刻蚀深槽。
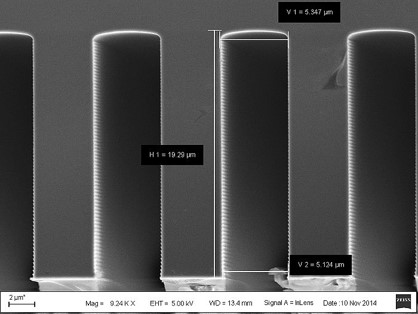
该设备以深硅刻蚀工艺为主,不接受金属掩膜样品刻蚀,机台为6英寸,可向下兼容小尺寸样品;如果样品为非标准尺寸,需要用粘片方式刻蚀;
该设备可接受各种光刻胶掩膜,SiO2或SiNx,各种有机薄膜等,不接受金属掩膜。