| 型号: | MA/BA6 |
|---|---|
| 功能: | 1. 微纳结构与器件图形光刻; 2. 双面对准光刻。 |
| 工程师: | 王老师 / (021) 34206126-6005 / fdwang@1 |
| 设备地点: | 西区光刻I区 |
| 设备编号: | WPHSMAL01 |
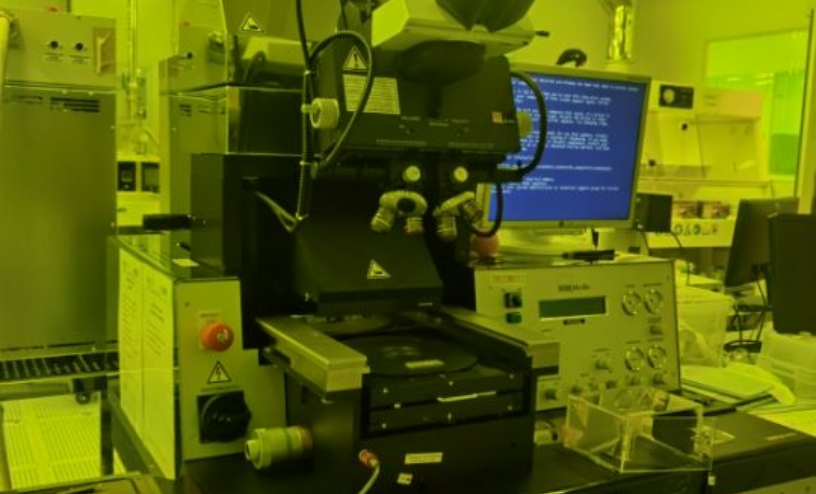
微纳器件中加工微米级结构图形。通过将设计好的电路图案转移到光刻胶上,再经过刻蚀等工艺将其变为实际的电路图案。
微纳器件加工中曝光微米级结构图形,分辨率: 0.8μm ,正面套准精度:±0.5μm ,背面套准精度:±1μm ,支持6、4、3英寸以下及破片。
分辨率: 0.8μm ,正面套准精度:±0.5μm ,背面套准精度:±1μm ,支持6、4、3英寸以下及破片。
工作原理是通过控制光强和时间,将掩模版上的图案曝光在旋涂好的光敏材料上,显影后实现将图案转移到基底上。
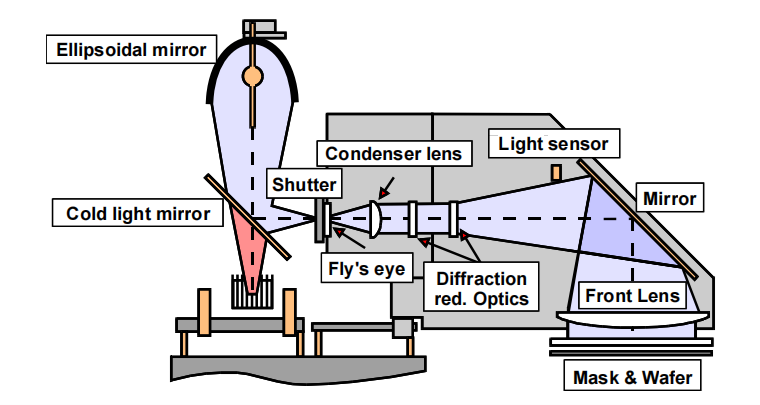
MEMS工艺加工,先进封装,微流控,光学器件制造,RDL布线和基本研究开发等。
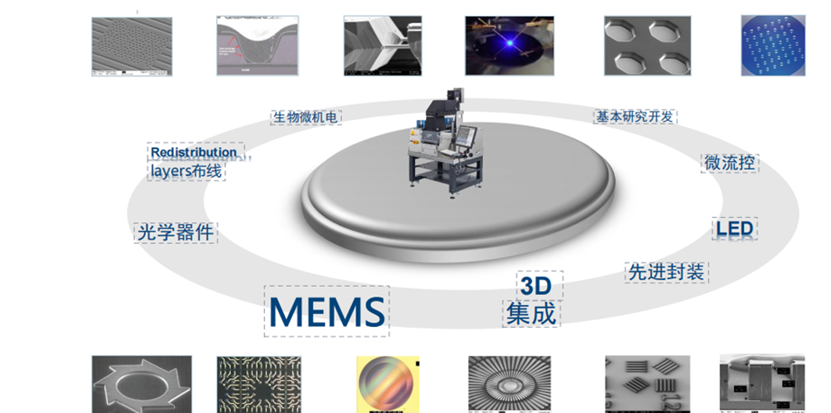
1.支持6“以下晶圆及碎片,样品正面与背面均需要保持平整洁净,全套工艺含匀胶、热板、显影及普通显微镜观察。
2.特殊光刻胶费用另计。
3. 厚胶工艺另计。
4. 不含基片与掩膜版。
5.掩模版尺寸要求: 支 4", 5" 7" 掩模版。
1.支持6“以下晶圆及碎片,样品正面与背面均需要保持平整洁净,全套工艺含匀胶、热板、显影及普通显微镜观察。
2.特殊光刻胶费用另计。
3. 厚胶工艺另计。
4. 不含基片与掩膜版。
5.掩模版尺寸要求: 支持4", 5" 7" 掩模版 6.必须取得上机资格认证才能自主上机。
请及时清洁片子背面