| 型号: | PlasmaPro 100 ICPCVD180 |
|---|---|
| 功能: | 样品尺寸不大于6英寸,低温沉积二氧化硅,氮化硅薄膜 |
| 工程师: | 付老师 / (021) 34206126-6010 |
| 设备地点: | 西区薄膜II区 |
| 设备编号: | WF2PCVD01 |
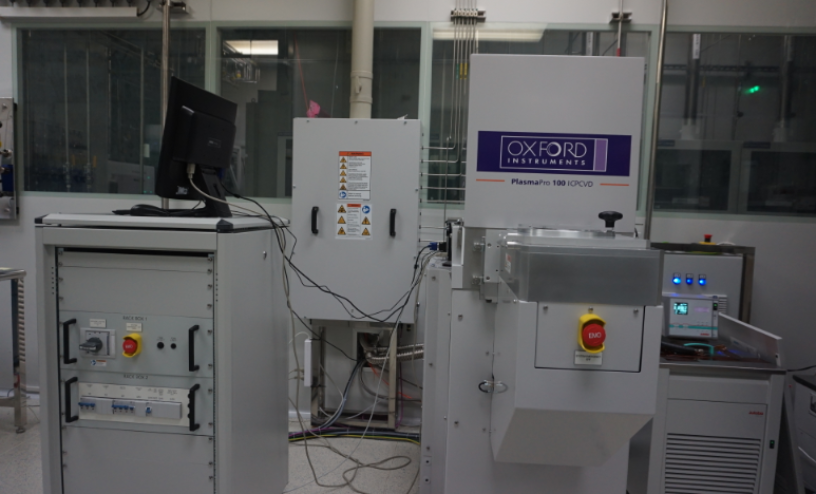
低温沉积二氧化硅,氮化硅薄膜,满足剥离工艺的需求。高温沉积高质量的氮化硅,氧化硅,氮氧化硅以及非晶硅薄膜
满足沉积10微米以下的二氧化硅薄膜的需求,满足沉积5微米以下的氮化硅薄膜的需求。可以制备10Mpa以下的超低应力介质薄膜。
高纯氮气或笑气单独自上进入反应腔,被交变电场激励。硅烷在样品表面附近进入腔内,与氮离子反应,生成氮化硅薄膜。背冷氦气由基板上的气孔通入,对基板上的衬底进行散热和温控。衬底被石英压环紧压,防止氦气漏入腔体,对工艺有影响。由于等离子体远离衬底,沉积的薄膜表面损伤会大大减少。这种间接ICP-PECVD的构造虽然等离子密度很高,但基板上的离子能量很低,生成的氮化硅薄膜表面钝化质量高,热稳定性好。
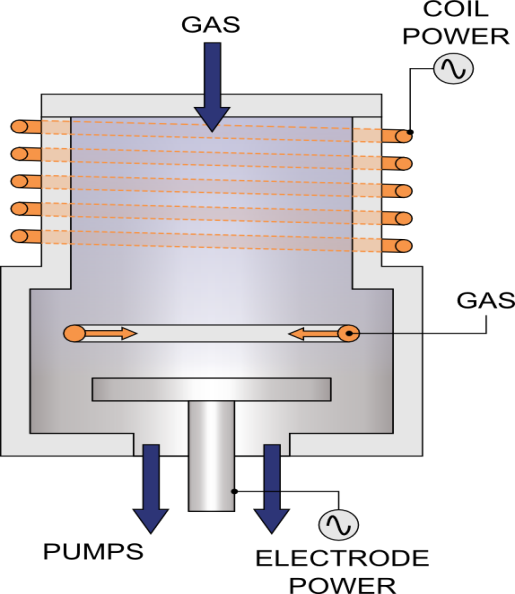
低温制备二氧化硅超厚膜。

沉积温度65℃制备厚度15.4微米,超厚二氧化硅薄膜,薄膜无开裂,无形变,无孔洞,有晶向。
样品尺寸不大于6英寸,低温沉积二氧化硅,氮化硅薄膜
涉及特气,电离辐射,注意操作规范。
及时联系工程师查找记录,确定已完成的的时间,争取让实验正常完成