| 型号: | LKJ-ID-150 |
|---|---|
| 功能: | 1. Al、Ni、Cr、Ti等金属薄膜RIE刻蚀; 2. 多晶硅刻蚀; 3. III-V族半导体刻蚀。 |
| 工程师: | 毛老师 / (021) 34206126-6009 / maohaiping@1 |
| 设备地点: | 西区薄膜IA区 |
| 设备编号: | EMCAIBE01 |

本设备是利用低能量平行Ar+离子束,对基片表面进行刻蚀。它采用纯物理的刻蚀原理,分辨率、陡直性好。它可以对所有材料进行刻蚀,例如,金属,合金,氧化物,化合物等。
1,刻蚀均匀性与重复性:4英寸衬底均匀性优于±5% ,重复性优于±5%
2,可进行离子束清洗及材料表面终极抛光
当定向高能Ar+离子向固体表面撞击时,能量从入射离子转移到固体表面原子上,如果固体表面原子间结合能低于入射离子能量时,固体表面原子就会被移开或从表面上被除掉。表面上未被掩膜覆盖部分的材料被去除,从而达到选择刻蚀的目的。
1, 使用离子束刻蚀光波导结构前(上)后(下)对比照
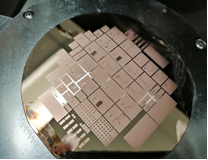
2, 使用离子束刻蚀系统刻蚀用于制作传感器件的镀金石英片,平均刻蚀速度4nm/min,中间与边缘非均匀性约5%.满足实验需求
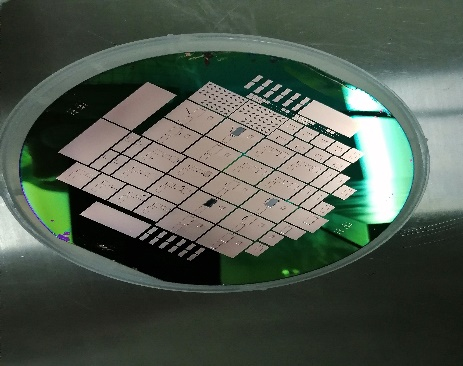

4英寸以下厚度在4毫米以下衬底,均匀性要求不高±5%,无衬底温度升高限制样品。
样品4英寸,只有氩气干法刻蚀,没有其他化学反应气体。费用最低0.5小时起算,具体操作见操作手册。
阴极灯丝断了,重新更换新的