| 型号: | EBPG 5200 |
|---|---|
| 功能: | 8英寸及以下基片纳米级结构直写光刻 |
| 工程师: | 徐老师 / (021) 34206126-6018 / xu.jian@1 |
| 设备地点: | 西区光刻I区 |
| 设备编号: | WPHVEBL01 |
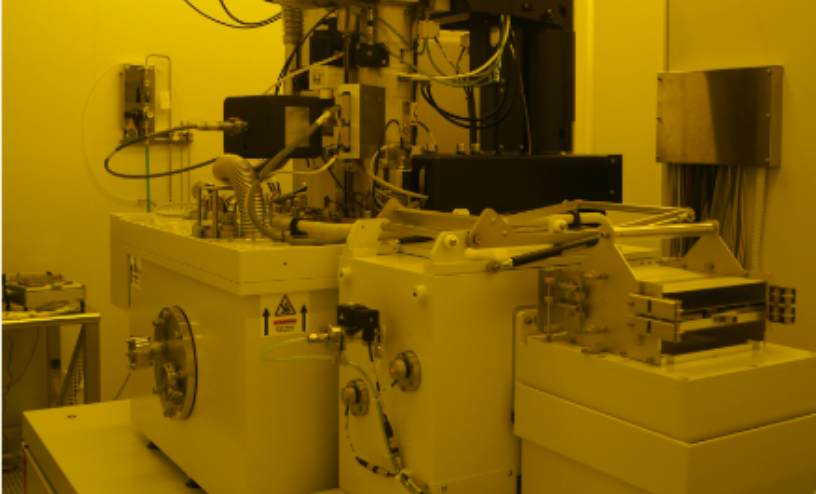
微纳器件加工中曝光纳米级结构图型,可用于各种纳米结构及器件、光刻掩膜版以及纳米压印模板等的加工.
电子束光刻技术的原理基于电子与物质的相互作用。利用各级电磁透镜对来自电子源的电子束进行偏转聚焦,并通过束闸控制电子束的通断,达到在wafer上扫描出图形的目的。
LNO调制器
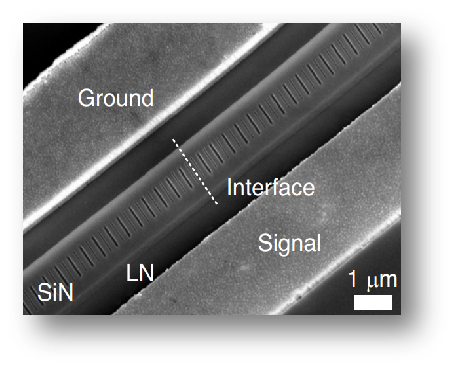
sub-100 nm二维光栅
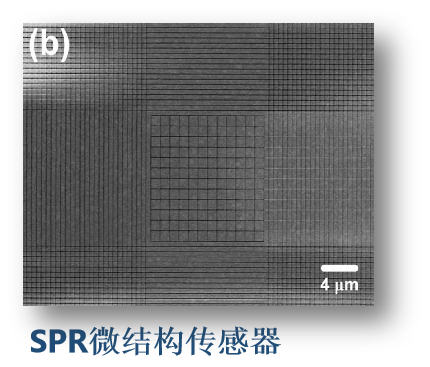
材料类型: 半导体标准硅片,能真空环境下使用,非磁性材料:
Si、GaAs、GaN、GaP,镀金属玻璃
基片尺寸: 2",3",4",Φ125mm, Φ150mm, Φ200mm
厚度:最大0.675mm
非标准基片尺寸应在10mm*10mm以上
掩模版(铬版尺寸): 3",4",5",6",7"
厚度: 最大0.09"@ 5"版
最大0.25"@ 6"版
直写图形面积: 最大 ~210mm*210mm
基片平坦度: 最大 +/- 30um peak to peak (无对准标记)
最大 +/- 50um peak to peak(带对准标记)
(非标准片,如果厚度特殊,需要另准备3块相同厚度的样品做高度参考)
PMMA, CSAR62. (HSQ,ZEP可自带)
平台主页查看预约须知