| 型号: | Explorer-14 |
|---|---|
| 功能: | 用于溅射沉积各类金属薄膜; 反应溅射沉积多种氧化物、氮化物薄膜; 具备原位基片清洗功能。 |
| 工程师: | 付老师 / (021) 34206126-6010 / xuecheng.f@1 |
| 设备地点: | 西区薄膜IA区 |
| 设备编号: | WF1DMSP01 |
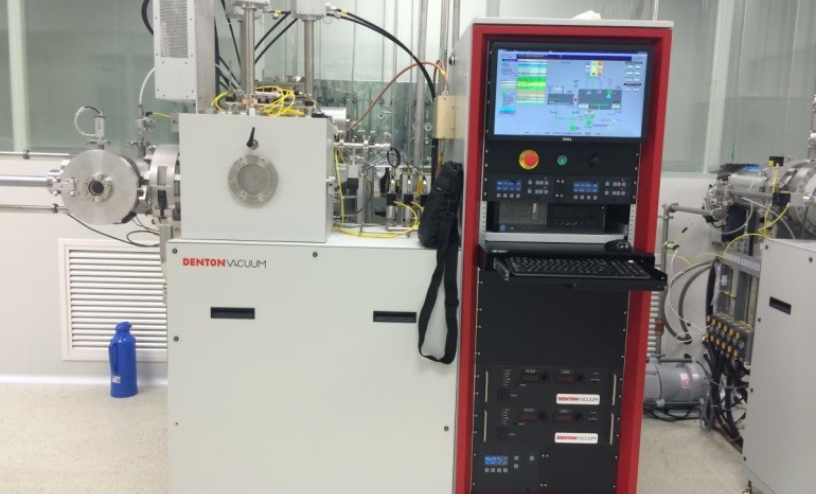
可溅射沉积厚度可控的铬、铜、银、铝、钛、钼、ITO、AZO、TiNX等多种金属、半导体、陶瓷薄膜。
最大沉积厚度一般不超过3um,沉积金属薄膜的电阻率可以根据需求调节。
利用电场或射频,将工作气体氩气电离。再利用磁场束缚电子的运动,提高电子的离化率,从而提高等离子密度,提高溅射速率。当足够高能量的粒子(大于溅射阈值)轰击靶材表面,使其中的原子发射出来,沉积在衬底表面,实现溅射镀膜。

利用多靶交替溅射沉积15nm周期性的薄膜,制备热电薄膜器件。膜厚精确可控,均匀性在±2%以内。
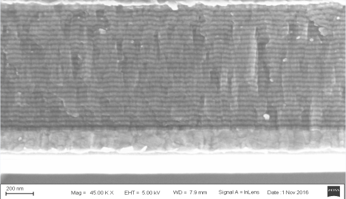
不接受衬底加热超过100℃样品。不接受过于潮湿的样品(厚胶3微米以上),不接受溅射磁性材料(Fe\Ni)样品。不接受大于6英寸样品。不接受在微小颗粒(毫米级以下)样品上镀膜。
更换靶材前务必关闭电源。
溅射时陶瓷靶材会碎裂,可能会溅射到靶枪上。绑定铜背板可以延长靶材的使用寿命
反应溅射遇到靶中毒是常见的事情,设定功率时要保守一些,保证溅射时功率始终如一即可
金属被氧化或氮化反应后,电阻增加,靶枪功率会下降,阴极电压升高
磁性靶材可以削弱磁场,不容易辉光,还会削弱靶枪磁铁磁性。