| 型号: | M600 |
|---|---|
| 功能: | 常温、高温条件下均可沉积高质量、厚度精确可控制的金属单质及氧化物半导体、化合物等多种薄膜。 |
| 工程师: | 付老师 / (021) 34206126-6010 / xuecheng.f@1 |
| 设备地点: | 东区薄膜Ⅳ区 |
| 设备编号: | EFM3MMS01 |

沉积高质量、厚度精确可控制的金属单质及氧化物半导体、化合物等多种薄膜,例如Cr、Cu、Ni、Al、Ge、Ti、Pt、Ta、SiO2、MO、W、ITO、TiNx等金属单质、氧化物、氮化物薄膜。
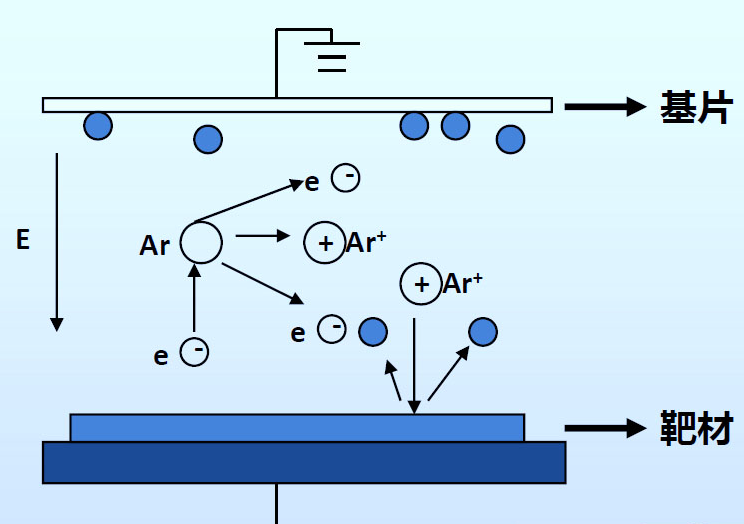
在高真空环境中充入氩气,施加高压电场后,电子被加速并与氩原子碰撞,产生Ar⁺离子和更多电子,形成等离子体。
Ar⁺离子在电场作用下高速轰击靶材表面,使靶材原子脱离并溅射。
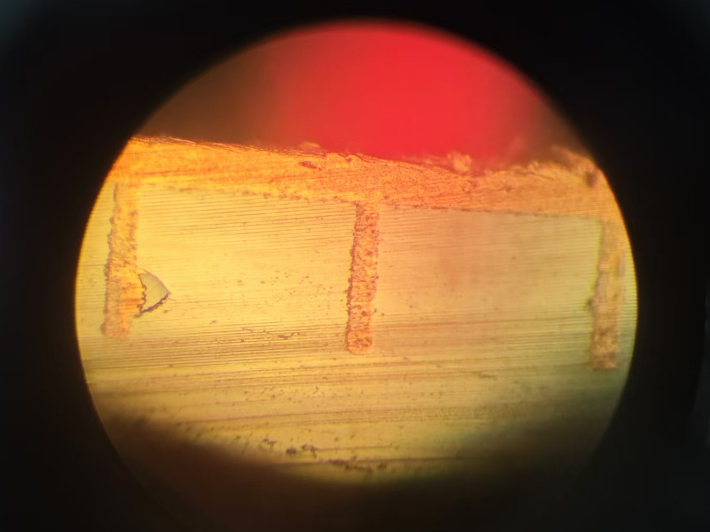
采用多靶材共焦溅射,在深宽比6:1的硅孔内沉积种子层电镀后的效果图
变价化合物推荐自备化合物靶材
这个设备具备2个直流、2个射频电源、在使用射频溅射光学薄膜时,可以辅助偏压。例如制备TIO2薄膜的折射率更高
深宽比不高于1:1时,理论上是可以的
造成金属薄膜脱落的主要原因往往是有机污染或者不规则结构引起的应力过大