| 型号: | NLD570 |
|---|---|
| 功能: | 干法刻蚀设备,主要用于高深宽比石英材料刻蚀,铌酸锂晶体刻蚀等。 |
| 工程师: | 刘老师 / (021) 34206126-6013 / minliu@1 |
| 设备地点: | 东区薄膜Ⅳ区 |
| 设备编号: | EFM4HAD01 |
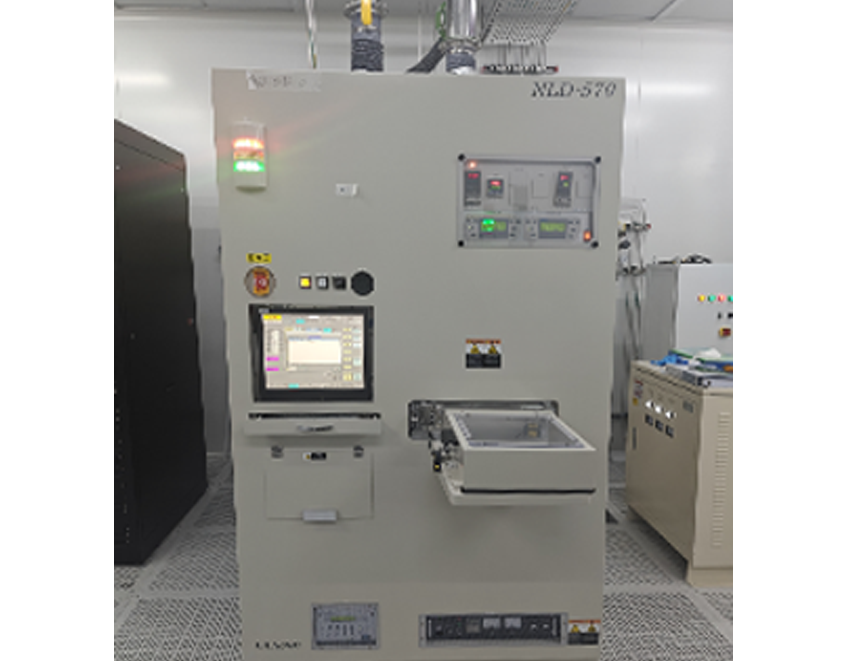
光学器件(光波导、放大器、光开关等等)、凹凸型微透镜等器件的刻蚀工艺加工。
对于石英刻蚀,可以达到3:1深宽比(@30um 孔径),对PR选择比>1.5:1;铌酸锂刻蚀,>3:1深宽比(@1um线宽),Cr或Ni选择比>3:1.
设备支持8英寸基片,向下兼容各种尺寸小片及破片;对于石英和铌酸锂刻蚀,片内均匀性<5%,片间均匀性<5%.
NLD(neutral loop discharge,磁中性环路放电)较ICP而言,可在真空腔内形成高频电场,并由此产生等离子体。通过改变电流大小可以控制等离子体的直径及密度,所以具有高刻蚀速率、高均匀性、高等离子体密度及低压放电等优点。
图为使用该设备对石英材料的深刻蚀
设备最大支持八英寸,不接受带有污染性的样品,请提前咨询沟通好工艺再预约。
可以使用各种掩膜,包括光刻胶(正胶、负胶包括SU8等)金属掩膜如Cr、Ni等。