| 型号: | C200 |
|---|---|
| 功能: | 1.刻蚀氧化硅、氮化硅、氮氧化硅等介质薄膜; 2. 刻蚀碳化硅薄膜; 3. 石英刻蚀。 |
| 工程师: | 刘老师 / (021) 34206126-6013 / minliu@1 |
| 设备地点: | 东区薄膜Ⅲ区 |
| 设备编号: | EFM3RID01 |
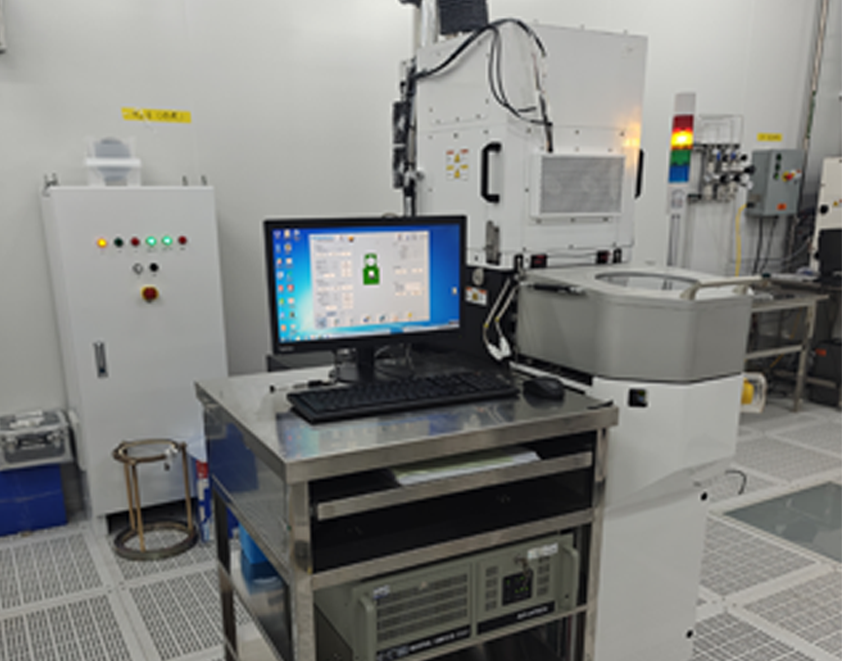
主要用于以下材料的刻蚀:1.氧化硅、氮化硅、氮氧化硅等介质薄膜; 2. SiC薄膜; 3. 石英等
对于二氧化硅或氮化硅的刻蚀速率大于200nm/min,与光刻胶的选择比约为2:1, 刻蚀侧壁的角度大于85度;片内均匀性低于5%;
机台为8英寸,ICP功率1500w,偏压功率500w,刻蚀气体为CHF3、SF6、CF4、Ar、O2、N2等。
ICP-RIE(电感耦合等离子体-反应离子刻蚀)是将ICP与反应离子刻蚀(RIE)技术相结合的先进技术,旨在提高刻蚀速率、高选择性和低损伤刻蚀。由于等离子体可以保持在低压下,因此还提供了出色的轮廓控制。
首先,ICPRIE系统引入特定的刻蚀气体,然后将射频电源(通常是13.56MHz)引入一个导体线圈,这个线圈通常位于等离子反应室顶部,和反应室的气体分隔开来。当射频电源通过导体线圈时,会在导体周围产生震荡的电磁场。这个震荡的电磁场能量通过感应耦合的方式传递给反应室中的气体,导致气体分子中的电子被激发并从原子中解离出来,形成自由电子和正离子。这些自由电子在电磁场中继续获得能量,并且与更多的气体分子碰撞,导致更多的电子被解离,形成高密度的等离子体。
图为用于绝缘功能的SiO2的各向异性刻蚀。
不接受金属掩膜样品刻蚀,不接受大于8英寸样品,不接受带污染的样品;
该设备接受各种光刻胶、有机材料等作为掩膜。