| 型号: | SI 500D |
|---|---|
| 功能: | 用于低温(130度)沉积SiO2、SiNx、TEOS等薄膜。也可以沉积掺杂PSG、BSG以及BPSG等薄膜材料。 |
| 工程师: | 刘老师 / (021) 34206126-6013 / minliu@1 |
| 设备地点: | 东区薄膜Ⅳ区 |
| 设备编号: | EFM4ICP01 |
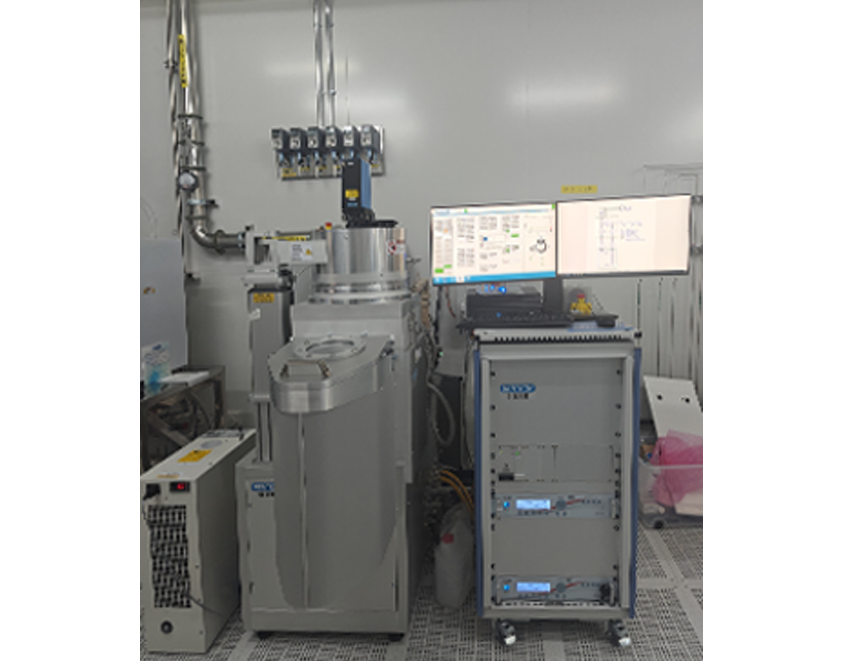
ICPCVD全称是电感耦合等离子体化学气象沉积(Inductively Coupled Plasma Chemical Vapor Deposition)。该方法利用高密度等离子体在低温下沉积高质量的介质薄膜,广泛应用于半导体和光电器件的制造。
可以沉积标准折射率的SiO2、Si3N4、TEOS等薄膜,也可以沉积各种掺杂的SiO2薄膜,包括掺杂P、B等元素。
设备支持8英寸加工,也可以用于6、5、4、3等小片或破片的加工。8寸片的均匀性SiO2<3%, SiNx<5%。
在 ICPCVD 中,电感耦合线圈在创造强大的等离子体环境方面起着至关重要的作用。该线圈通常安装在反应室周围,可产生强大的电磁场,使反应气体电离。由此产生的高密度等离子体不仅能加速薄膜形成所需的化学反应,还能在基底表面均匀分布能量。这种均匀性对于在整个基底上获得一致的薄膜特性(如厚度、密度和附着力)至关重要。
图为在八英寸硅片上使用TEOS沉积的SiO2薄膜
PECVD为清洁制程不接受带污染的样品;如果需要沉积掺杂B、P的BSG、PSG和BPSG,需要事先和工程师沟通确认。
可以,设备为ICPCVD,可以低温沉积。