| 型号: | AM222-TPPP |
|---|---|
| 功能: | 可实现高质量压电薄膜AlN和AlScN,和金属Mo的沉积,并现实薄膜的超平整修整工艺。 |
| 工程师: | 乌老师 / (021) 34206126-6028 / lynn_wu@1 |
| 设备地点: | 东区薄膜Ⅳ区 |
| 设备编号: | EFM4HVM01 |
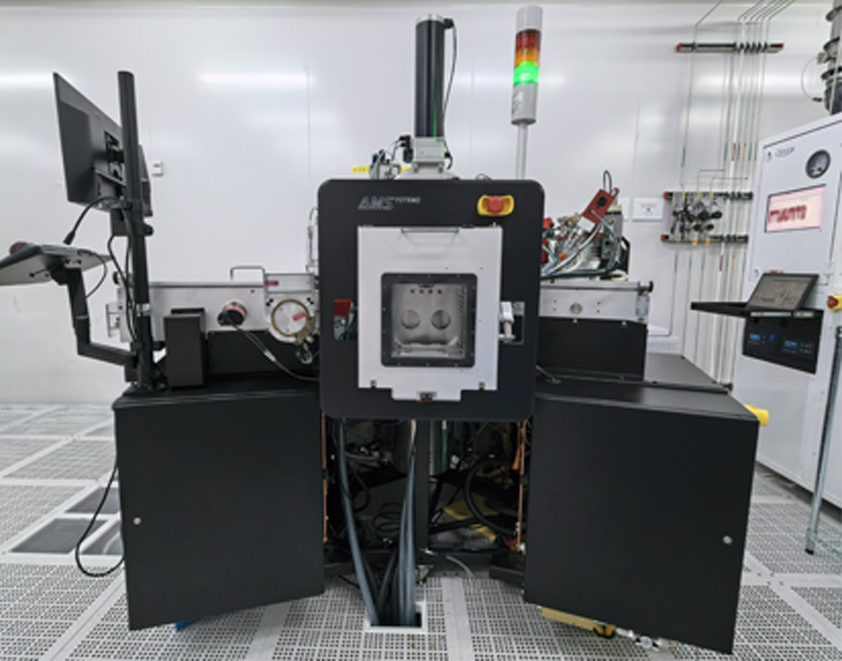
该设备是一台高度集成的多腔室磁控溅射设备,专为研发和制备高性能的微电子/声学器件(如BAW滤波器、SAW器件、MEMS传感器等)而设计。共有4个工艺腔室,包含AlN薄膜溅射腔室、AlScN薄膜溅射腔室、金属Mo溅射腔室,以及对薄膜进行离子束精细磨平修整的腔室。设备的核心用途是制备以氮化铝(AlN) 和钪掺杂氮化铝(AlScN) 为关键功能材料的压电薄膜器件。因溅射沉积的薄膜表面可能不够平整,粗糙的表面会严重损害高频器件的性能(如增加损耗),离子束修平腔室可以将其磨得极其平整。
可实现压电薄膜AlN和AlScN和金属Mo的沉积,并现实薄膜的离子束精细磨平修整工艺。工艺可保证薄膜晶体结构高度有序,AlN择优取向为(002)晶向,AlScN择优取向为(002)晶向,Mo择优取向为(100)晶向,薄膜晶体缺陷和应力小,非常适合SAW、F-bar等压电表面声波器件的制作。
1.基底需是完整晶圆,尺寸为4、6、8寸;
2.腔室真空度 5X10E-7 torr;
3.经过修平后的8寸片厚度均匀性(1 sigma/mean): a)1u AlN均匀性 <0.1% , b)500nm AlSc(30%)N均匀性 <0.1% c)300nm Mo均匀性 <0.7%;
4.薄膜晶体结构高度有序,AlN和AlScN择优取向为(002)晶向,Mo择优取向为(100)晶向;
5.经过修平后的晶体质量: a)AlN XRD摇摆曲线FWHM <1.5度 b)AlSc(30%)N XRD摇摆曲线FWHM<1.7度 c)Mo XRD摇摆曲线FWHM<2度。
高真空磁控溅射工作原理:
磁控溅射是一种利用磁场和电场共同作用,使靶材(如AlSc合金)在等离子体中被轰击,溅射出原子或分子,并在基片上沉积成薄膜的技术。
Trimming修整工作原理:
1. 晶圆以恒定速度移动,功率根据厚度或频率均匀性图进行调整。
- 晶圆在修整过程中以恒定速度移动,同时根据预先测量的厚度或频率均匀性图动态调整功率。
2. 为了调整从晶圆上去除的材料量,离子源功率会发生变化。
- 通过改变离子源功率来精确控制材料去除量。直流离子源在所有功率下都非常稳定,并且允许在毫秒级时间内快速调整功率。
- 当离子源扫描晶圆时,根据已下载到修整工具软件中的厚度图调整材料去除量。
3. 由于晶圆以恒定速度移动,AMS(先进修整系统)采用了一种简单且稳健的晶圆扫描机制。
- 低成本和简单的维护。
- 正常运行时间长。
4. 最小刻蚀速率为零,无需沉积额外材料,不会导致器件性能退化,尤其对声表面波(SAW)频率修整非常重要。
- 修整过程中最小刻蚀速率可以为零,这意味着不需要在晶圆上沉积额外的材料,从而避免器件性能退化。这对于声表面波(SAW)器件的频率修整尤为重要。
以下测量数据是该设备安装调试完成后,实际加工的8寸片在AEMD平台测试的结果:

1.为保证最优效果,基底硅推荐选用prime规格(平台可付费领取)。
2.做AlN、AlScN和Mo沉积时,Si基底不可用N型和低阻Si(< 5 Ω-cm),可能会破坏沉积效果。
3.本设备为大型多腔集成设备,为达到最好的效果(厚度均匀性、晶向等)推荐选择全套工艺,包含对基底的处理和修平。
4.如果仅想对基底做单纯的沉积,工艺条件中已单独列出(除了30% AlScN不提供纯沉积工艺),AlN和Mo均提供单纯沉积服务,但可能需要凑几批预约一同进行,时间上可能不及时,望理解。
5.所有的腔室(沉积和修平)都不能接受破片,目前可沉积的尺寸为8寸,6寸,4寸。
6.所有的腔室(沉积和修平)收费统一按片/次收取,不论片子大小。
7.修平腔室的厚度偏差Total Thickness Variation (TTV=Max-Min)最大为30nm,超过该范围可能需要多次修平和多次收费。
8.目前平台提供的Sc掺杂为30%,如果有20% Sc掺杂需求请联系工程师。
9.大于10片以上与工程师联系,可以优惠。
不可以,仅能加工完整的晶圆