| 型号: | µGALV |
|---|---|
| 功能: | 电镀填充硅盲孔、硅通孔、玻璃盲孔、玻璃通孔等高深宽比结构。 |
| 工程师: | 田老师 / (021) 34206126-6031 / miaotian@1 |
| 设备地点: | 东区电镀区 |
| 设备编号: | EPL0TSV01 |
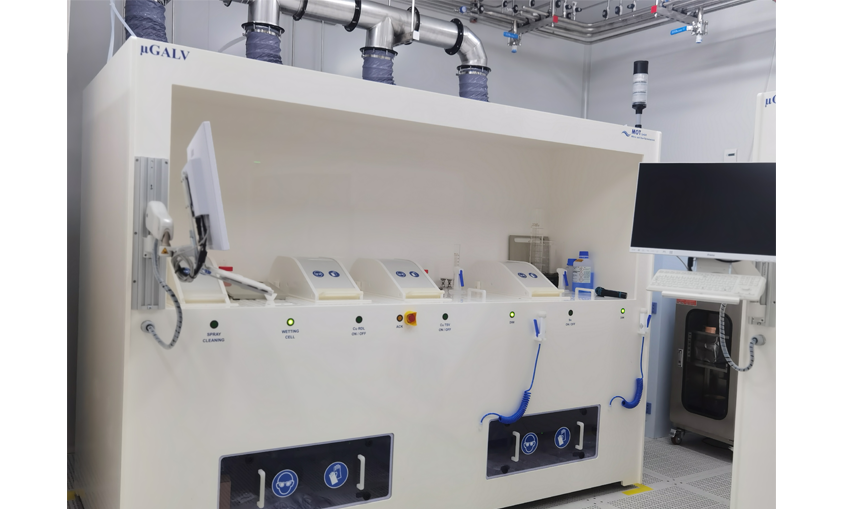
电镀填充硅盲孔、硅通孔、玻璃盲孔、玻璃通孔等高深宽比结构。只可沉积金属铜。不同深宽比和孔径的填充效果不同。
3、4、6寸标准尺寸晶圆。 晶圆厚度:350um-1000um。 150mm尺寸以下异形样品(含破片)。最小可填充盲孔为直径10um,孔深100um。
3、4、6寸标准尺寸晶圆。 晶圆厚度:350um-1000um。电流可控精度1mA。电镀时长可超过100小时。可以台阶电流,可以脉冲电流。
利用电化学方法在基体表面沉积铜层的工艺。其电镀液有硫酸铜、导电盐、pH调节剂等组成。电镀过程中将基体作为阴极,通电后,铜离子在阴极表面还原析出,形成铜镀层。
深宽比为10:1的深孔的填充效果。
3、4、6寸标准尺寸晶圆。 晶圆厚度:350um-1000um。请务必提前联系工程师。由于不同孔型填充效果各异,请准备测试样品。
至少200nm,保证孔内连续。