倾斜侧壁刻蚀工艺
在光电子器件的制备工艺中,绝大多数器件工艺对刻蚀侧壁形貌的要求是侧壁垂直,然而某些器件的特殊结构比如图形衬底、多台面金属爬坡工艺等都需要对材料进行有角度的侧壁刻蚀。
AEMD平台采用国际先进的微纳加工技术,基于成熟的光刻、干法刻蚀等技术,具备倾斜角度可调且表面光滑的侧壁刻蚀能力。
倾斜侧壁结构的应用
- MEMS器件中的二氧化硅牺牲层
- 提高侧壁覆盖性的具有倾斜角度的绝缘介质层
- 光学产业中的微透镜、微槽、微锥、微棱镜等三维表面结构
AEMD现有工艺能力展示
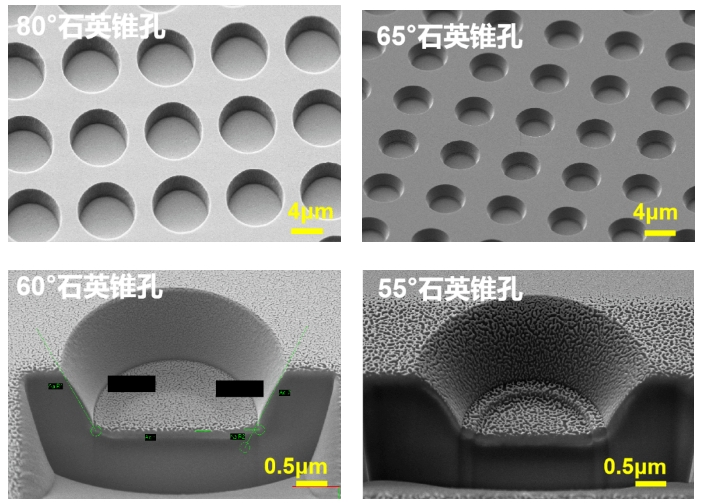
AEMD平台倾斜侧壁加工工艺能力
- 刻蚀形状可为台面刻蚀或者孔刻蚀。
- 刻蚀表面质量好,刻蚀后表面质量与刻蚀前值相当。
- 图形最小特征尺寸可达5um。
- 刻蚀材料可为石英体材料或氧化硅薄膜材料等。
- 加工面积:最大加工面积为6英寸,并向下兼容破片。
- 平台可提供定制化服务,根据客户的应用条件和环境变量,设计锥台/锥孔刻蚀工艺。具体可联系工艺工程师咨询。








