| 型号: | ACT8 |
|---|---|
| 功能: | 在180 nm半导体工艺节点中全自动涂胶显影 |
| 工程师: | 徐老师 / (021) 34206126-6052 / hui.xu25951@1 |
| 设备地点: | 东区光刻Ⅱ区(Canon) |
| 设备编号: | ELT2ACT01 |
支持4/6/8寸半导体标准晶圆的HMDS疏水性改性、光刻胶旋涂、软烘、PEB前烘、puddle静态显影、后烘等工艺处理;支持6/8寸与Canon DUV Stepper全自动涂胶曝光显影工艺。
膜厚均一性精度≤1%,晶圆面内显影后线宽均一性CDU 3σ≤10%,热板加热温度范围50℃~350℃。
1.提供涂胶前疏水性改性处理,使用HMDS(六甲基二硅氮烷);
2.光刻胶旋涂及切边处理,膜厚可调,切边宽度可控;
3.软烘/PEB/硬烘处理,热板选择多样,温度可选范围50℃~350℃,精度高;
4.显影处理,使用静态puddle显影处理,SH nozzle及LD nozzle流量大但冲击力小,显影后使用DIW及高速旋转冲洗晶圆,保证晶圆表面干燥;
5.高速冷板降温,晶圆60s时间即可降温到23℃;
6.全自动处理,根据工艺需求可组合使用上述功能,亦可单一实现其中一个功能;
7.HMDS-涂胶-软烘-冷却:7min/pcs;
8.PEB-冷却-显影-硬烘-冷却:8min/pcs。

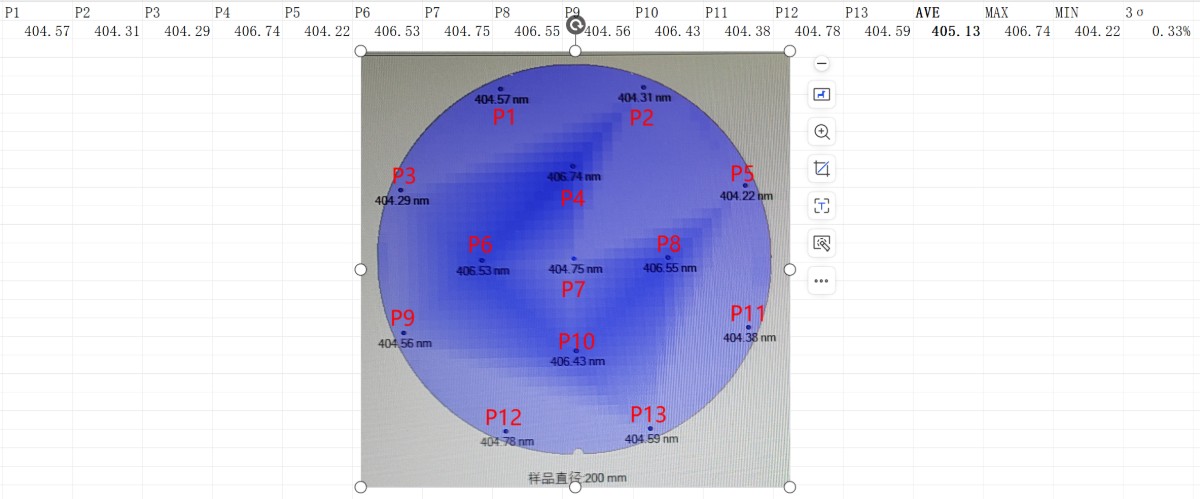
8寸半导体标准晶圆(4/6寸请联系相关工程师)。
切换不同晶圆尺寸需要2周时间,具体的设备状态请关注网站或AEMD平台公告。
resist pump仅支持安装低粘度光刻胶,不支持厚胶。
不支持。
不支持,仅支持4/6寸flat及8寸notch晶圆。