| 型号: | STM7 |
|---|---|
| 功能: | 主要用于微纳加工样品的结构观察及测量 |
| 工程师: | 沈老师 / 34207734-8010 / shenyunliang@1 |
| 设备地点: | 西区薄膜IA区 |
| 设备编号: | WF1STMO01 |

主要用于微纳加工样品的结构观察及测量,也可以适用于超出视场范围大样品测量。
验收标准L=100mm,L=1mm量测结果L=99.9988mm,L=0.9991mm
验收标准 L=1.38mm量测结果 L=1.3806mm
验收标准H=131.7nm(by SEM)量测结果H=0.1297mm
验收标准L=100mm,L=1mm量测结果L=99.9988mm,L=0.9991mm;
验收标准 L=1.38mm量测结果 L=1.3806mm
验收标准H=131.7nm(by SEM)量测结果H=0.1297mm
测量显微镜采用主动反射、共聚焦方法的自动聚焦系统。
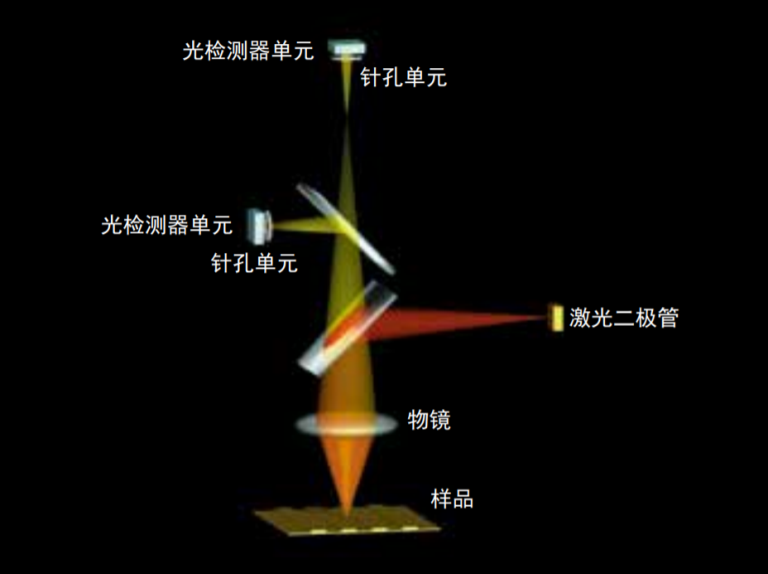
1.对于开口宽度为40μm、深度超过120μm(深宽比>3)的深硅刻蚀槽样品,深度测量误差≤5μm;验收标准H=131.7nm(by SEM)量测结果H=0.1297mm;
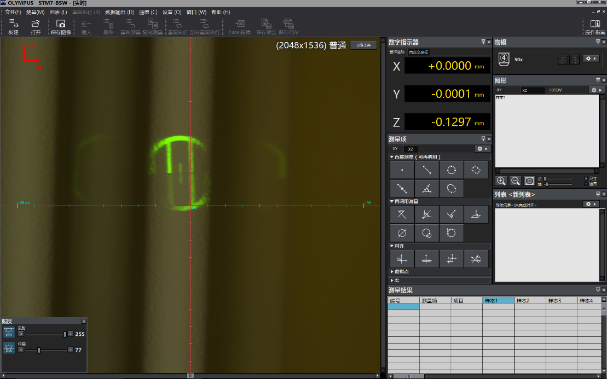
2.对于标准样品,Z轴测量精度≤5μm+3%*L,L为测量长度;验收标准 L=1.38mm量测结果 L=1.3805mm;

3.对于标准样品,平面测量精度≤3μm+2%*L,L为测量长度;验收标准L=100mm,L=1mm量测结果L=99.9988mm,L=0.9991mm;

主要用于微纳加工样品的结构观察及测量。
1. 样品<6inch,样品背面干净,使用完请将亮度调到最低。
2. 使用完后关闭软件。
3. 设备在运行过程中,请勿触碰设备以及操作电脑以免误碰引起设备停机或故障。
4. 如果发生设备报警,请通知相应的设备工程师。
测量显微镜可以测量超出视场范围大样品尺寸。