| 型号: | SE-2000 |
|---|---|
| 功能: | 用于探测单层或多层薄膜的折射率(n)、消光系数(k)及厚度等信息 |
| 工程师: | 瞿老师 / 34207734-8003 / minni.qu@1 |
| 设备地点: | 西区测试I区 |
| 设备编号: | WT1SELP01 |

设备提供紫外-可见-近红外(245 nm~1600 nm) 波长下的椭圆偏振光谱测试,可用于探测单层或多层薄膜的折射率(n)、消光系数(k)及厚度等信息。采用光学反射模式,测量过程无损、快捷。 可用于半导体中的氧化硅、氮化硅、氮氧化硅、high-k介电材料(如HfO₂等)、low-k材料、光刻胶、SOI、SiGe、SiC、多晶硅及应变硅等薄膜的测量;平板显示器中的IGZO、电致变色层;铁电材料等测量;用于AlGaN、GaN、InP等光电器件化合物半导体材料;以及太阳能电池中的透明导电物薄膜、纳米材料;OLED或OTFT中的有机薄膜的测量。 在超薄膜测量方面,可用于原子层沉积(ALD)生长的超薄介质膜测量,也可用于单层石墨烯等新型二维材料。同时,设备配备有非接触式涡流测量模块,可对样品提供无损、快速的(导电/半导体)薄层方块电阻测试。
波长测试范围:245nm~1600nm,对于120nm厚度SiO₂/Si标准样品,其测试厚度准确性≤±5Å,厚度重复性≤0.2Å,折射率准确性≤±0.009,折射率重复性≤0.002,消光系数重复性1sigma≤2%。方块电阻测试重复10次的可重复性:1sigma<3%。
可提供多层薄膜各层的拟合曲线:(下图是SOI基片上光刻胶样品的单点测试结果,从拟合曲线可以分析出光刻胶、顶硅、二氧化硅这三层薄膜的厚度及光学常数,其中光刻胶的厚度为64.6 nm。)
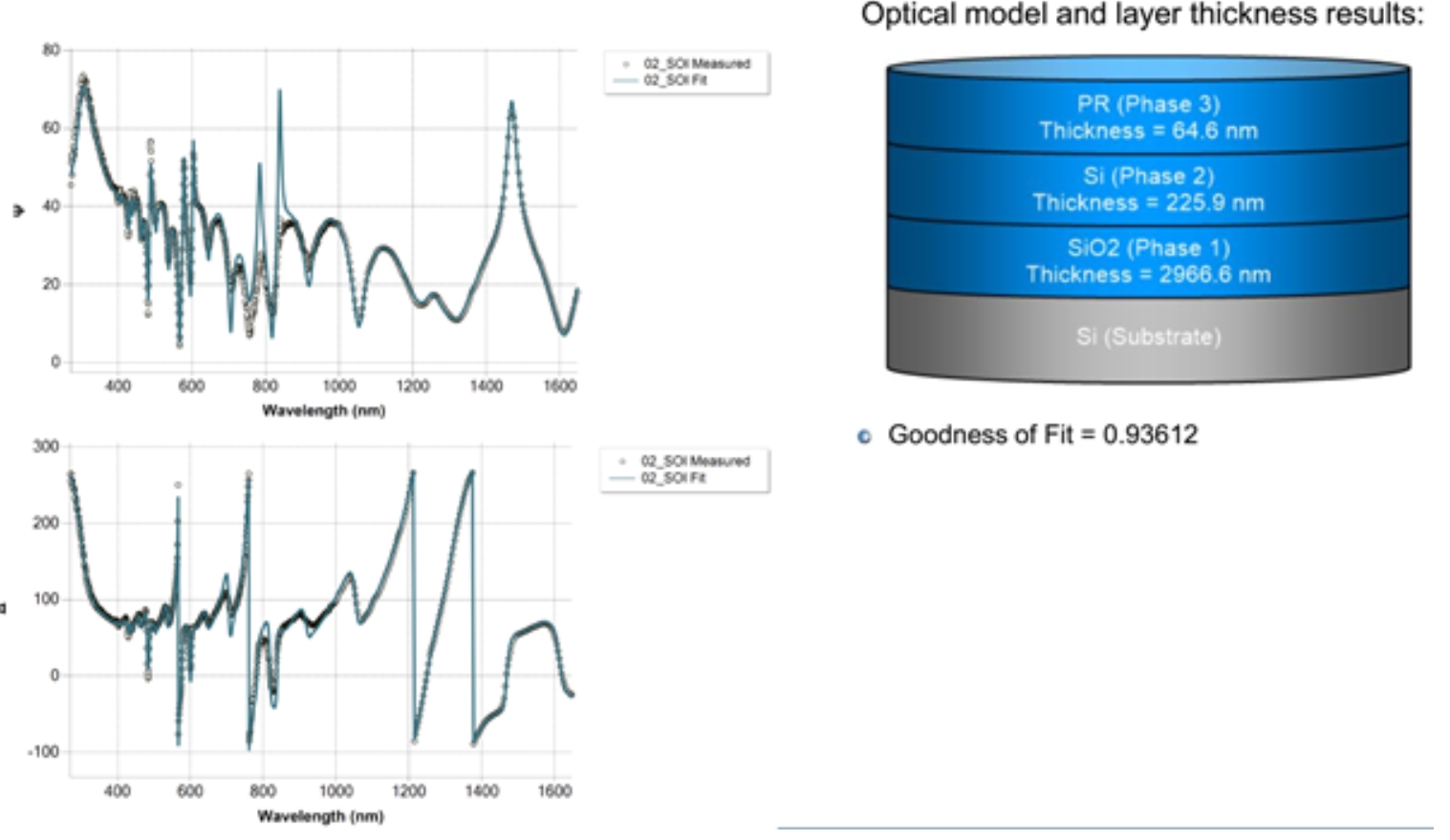
样品保持洁净,禁止用手直接触摸。晶圆样品大小不超过8inch。
手动模式下输入样品厚度使样品台上升时,需严格注意不能撞到Eddy探头。
由于样品厚度、成分等变化导致之前存储的测试菜单(recipe)不适用;