| 型号: | F50-UVX |
|---|---|
| 功能: | 薄膜厚度测量,可自动mapping |
| 工程师: | 瞿老师 / 34207734-8003 / minni.qu@1 |
| 设备地点: | 西区薄膜IA区 |
| 设备编号: | WF1TFMF01 |
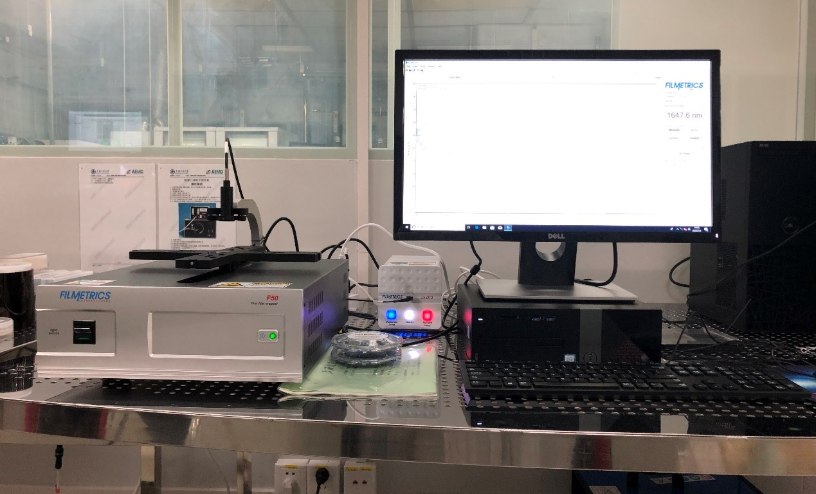
可对薄膜样品进行无接触的无损厚度测量,可测量薄膜厚度及光学常数,测量迅速、操作简单,精度通常可达到纳米或埃量级。波长范围可以从紫外到近红外可选,样品台支持12寸及以下晶圆,包括不规则形状破片,可做自动面扫描。常用于测量二氧化硅,氮化硅,硅,光刻胶等多种材料的薄膜厚度。
可用于二氧化硅,氮化硅,硅,光刻胶等多种材料的薄膜厚度的无损测量,广泛应用于从基础研究到工业生产的不同领域,如半导体材料、薄膜生长、光刻工艺监控等。
在测量样品表面垂直照射紫外可见光,光的一部分在薄膜表面反射,另一部分透过薄膜后在薄膜与下层材料之间的界面反射。这时薄膜表面的反射光与薄膜底部的反射光产生干涉现象,使得反射光的强度发生振荡,光强振荡与入射光波长及薄膜的厚度相关。
测Si+SiO₂片的SiO₂薄膜厚度mapping:
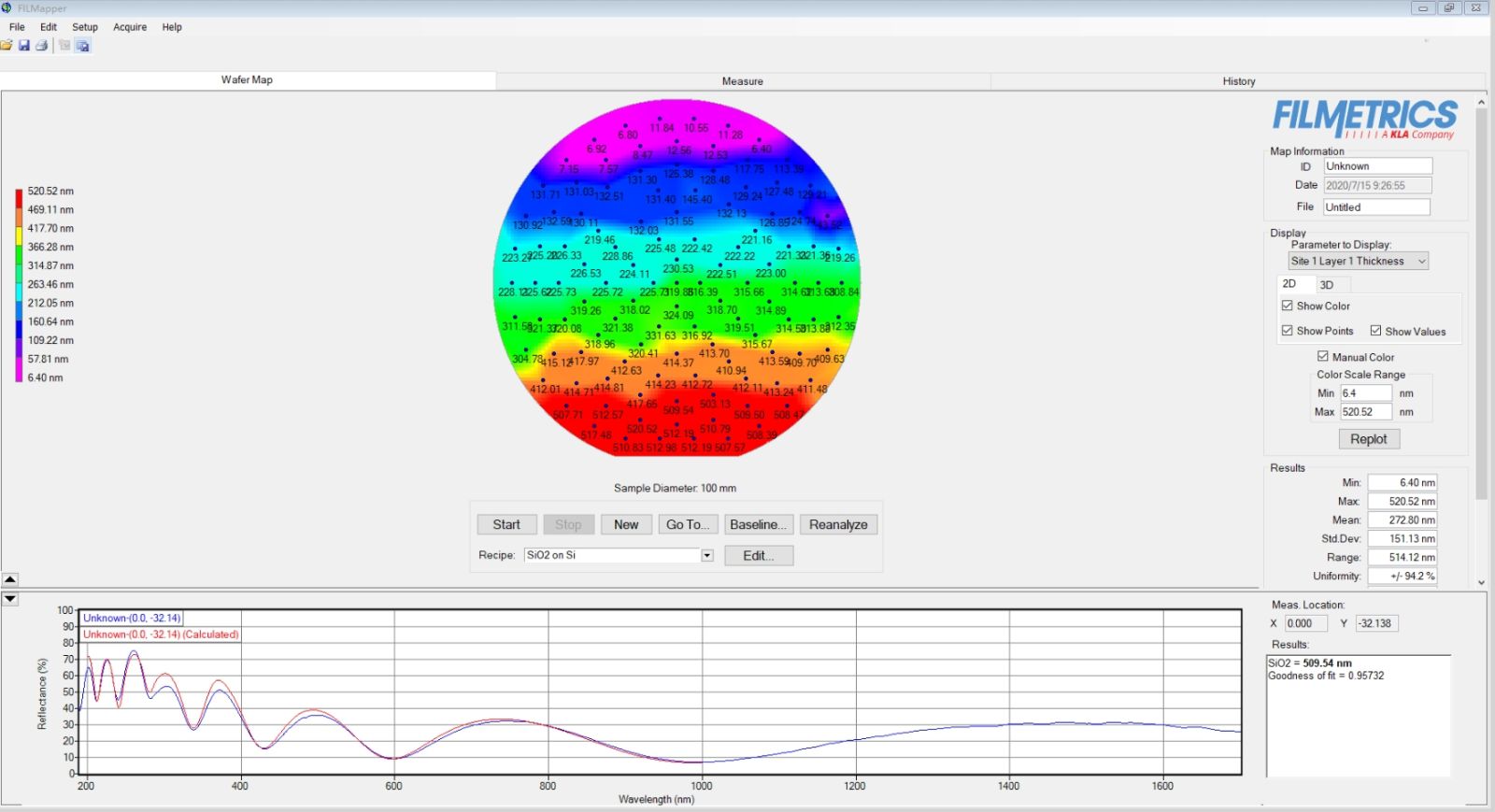
样品保持洁净,新材料、多层膜、厚度特别薄或特别厚等情况,请提前联系设备管理员。
使用紫外光源需提前联系设备管理员。测量结束后关闭所有光源。
异常原因: 挡板或光源开关没有打开,光源损坏;
处理方法: 检查挡板或光源开关按钮指示灯状态,正常打开为常亮,如有异常请联系工艺工程师。