| 型号: | F54-XY-200-UVX |
|---|---|
| 功能: | 无接触测量薄膜厚度,波长范围从紫外到近红外可选,自动样品台,图形识别功能可以实现精准微区位置的测量。 |
| 工程师: | 瞿老师 / 34207734-8003 / minni.qu@1 |
| 设备地点: | 东区测试III区 |
| 设备编号: | ETE3TMS01 |
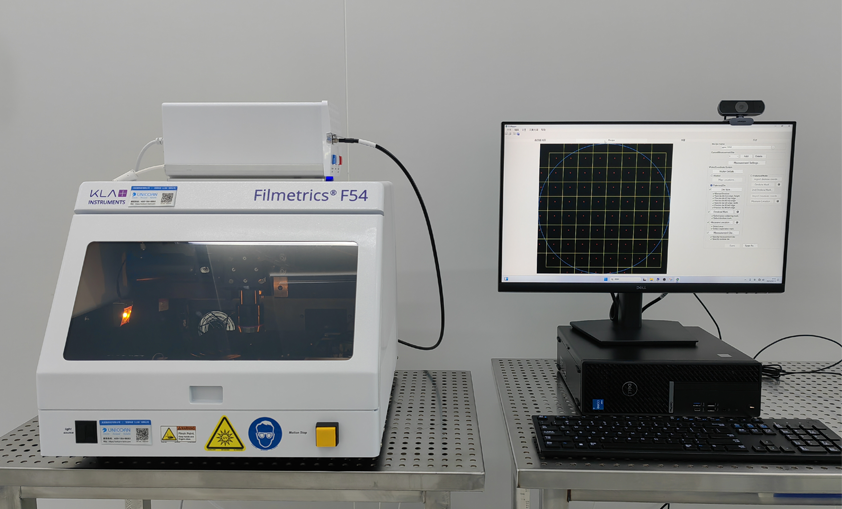
该设备可对样品进行无接触的无损测量,可测量薄膜厚度,测量迅速、操作简单,精度通常可达到纳米级。波长范围可以从紫外到红外可选,用来测量超薄膜、多层薄膜厚度等等,薄膜厚度从几纳米到百微米范围,自动样品台可以实现晶圆表面的自动厚度mapping。对于图形片测量,需要聚焦型光斑,并配合图形识别功能以实现精准微区位置的测量。在AEMD平台主要用于介质薄膜、有机薄膜、aSi等的厚度测量,对于已经图形化的图形,利用图形识别功能实现自动化微区测量。
波长范围190-1700nm,厚度测试范围4nm~115um,准确度0.2%或1nm(取较大者),光斑大小:17um(15X物镜,250um孔径),样品台直径200mm,XY移动平台,软件具有图形识别功能,可以快速自动多点测量有图形的晶圆。
光学膜厚仪利用光学反射干涉的原理,对膜厚的厚度及光学常数进行非接触的无损测量。
氧化硅薄膜经过CMP工艺后的厚度分布图:
17μm微光斑在SiO2图形片上20μm×20μm方形区域的微区测量:
样品保持洁净,新材料、多层膜、厚度特别薄或特别厚、图形片等情况,请提前联系设备管理员。图形片测试请与设备管理员联系,提供die尺寸及至少一个die内的图形照片。