尊敬的各位用户老师、同学:
为了满足学校广大师生的科研需求,AEMD平台新购置的中电流离子注入机(设备编号:EEI0MCI01)已完成安装调试,即日起开放运行。各位用户老师、同学可在AEMD预约系统里预约使用,特此公告。
中电流离子注入机介绍:
主要用途:
用于对半导体材料进行掺杂,改变其电学特性,如调整阈值电压、形成浅结 / 电阻、制备 CMOS 阱等。
工艺/测试能力:
提供B, BF2, P, As,Ar元素的注入,分解能>50;能量3--960keV,误差<1%;支持剂量1E11~1E16 atoms/cm2,Dose 误差<1%,;Tilt角度0-60°,角度误差<0.2°;电流范围:2μA~4000μA;片内,片间均匀性≤0.5%;
设备工作原理简介:
离子注入机是半导体制造过程中关键的精密设备,主要用于将特定元素的离子注入到半导体晶圆(如硅片)中,从而改变晶圆局部区域的电学特性(如掺杂浓度、导电类型等)。其工作原理可概括为离子产生→离子引出与加速→质量分析与筛选→离子束传输与扫描→离子注入到晶圆五个核心环节。
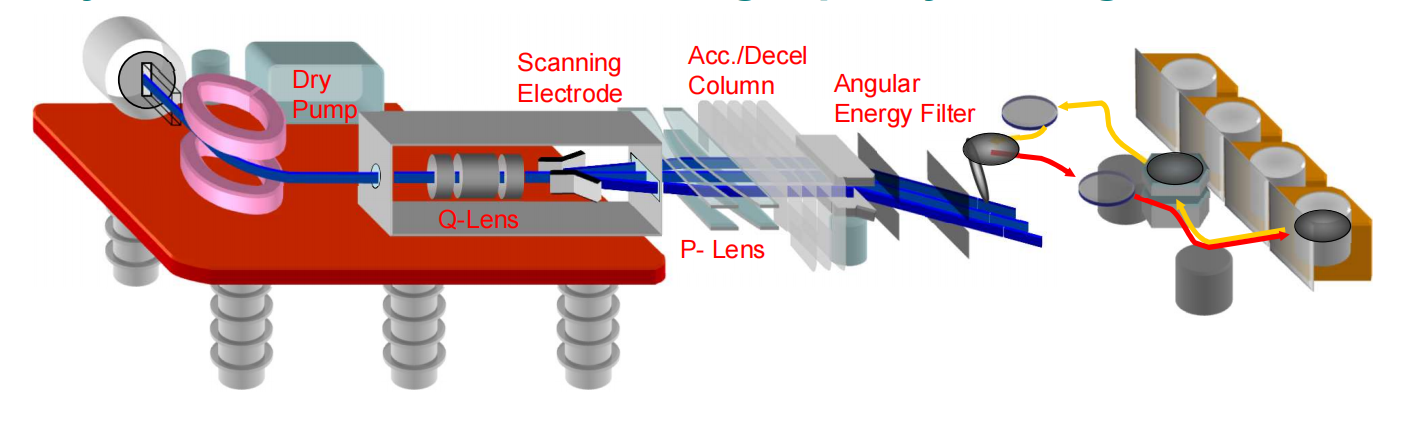
一、离子产生(离子源) 原理:通过电离过程将需要注入的元素(如硼 B、磷 P、砷 As、氩 Ar 等)转化为离子态。 方法: 热电离:加热固态使其蒸发,再通过电子轰击电离。 气体电离:对气态物质(如 BF3、PH3)进行电子轰击,使气体分子电离为离子(如 BF₂⁺、P⁺)。
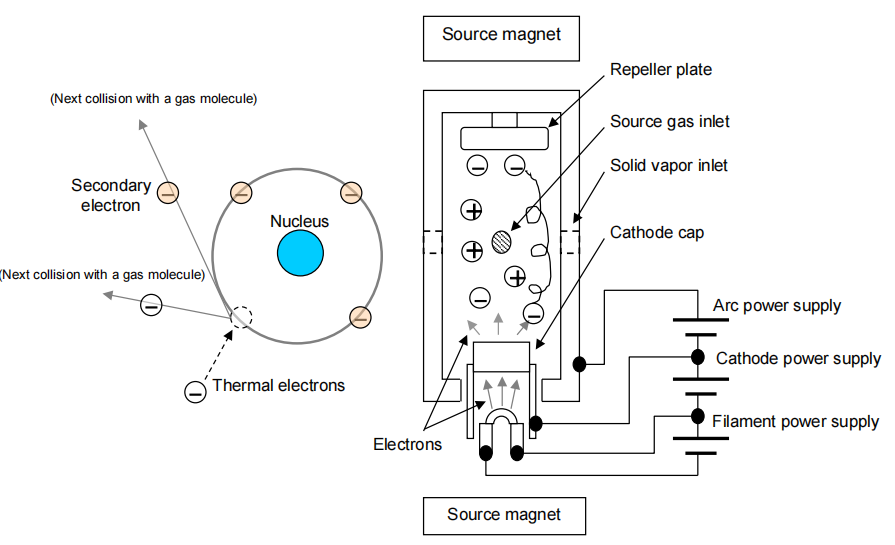
二、离子引出与加速(加速电场) 原理:利用电场加速将离子源产生的离子引出,并赋予其一定的动能。
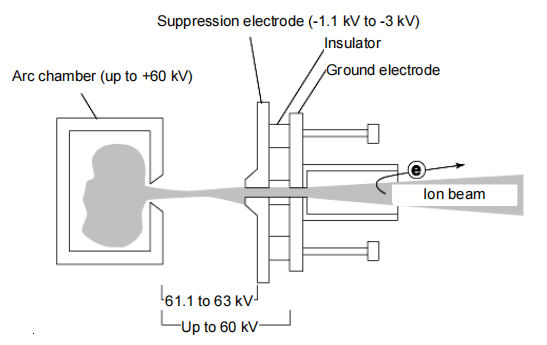
三、质量分析与筛选(磁分析器) 原理:利用磁场偏转原理筛选出目标离子(如排除杂质离子或同元素的不同同位素)。
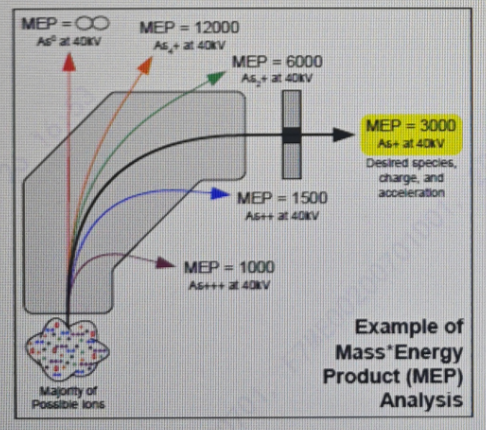
四、离子束传输与扫描(束流控制) 原理:通过电磁透镜和扫描系统控制离子束的形状、方向和位置,使其均匀覆盖整个晶圆表面。

五、离子注入到晶圆(靶室与晶圆台) 原理:经过筛选和扫描的离子束最终轰击到晶圆表面,离子通过动能沉积进入晶圆内部,形成掺杂层。
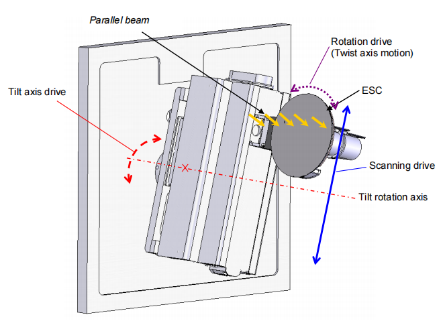
离子注入机通过 “离子产生→加速→质量筛选→扫描→注入” 的全流程控制,实现了对半导体晶圆的精准掺杂,是集成电路制造中不可替代的关键设备。其技术难点在于高能量精度、高束流纯度、高均匀性扫描以及复杂的真空和控制系统集成。
典型使用案例:
硼(B)受主杂质(P 型):
磷(P)施主杂质(N 型):
砷(As)施主杂质(N 型):
氟(F)界面调控:
设备名称:中电流离子注入机
设备编号:EEI0MCI01
工艺工程师:李老师;邮箱:[email protected] 电话:(021) 34206126-6012
设备地点:东区外延/离子注入区
设备详细介绍查看路径:AEMD官网-平台设备-微纳加工
AEMD官网网址:https://aemd.sjtu.edu.cn/
AEMD实验室设备预约管理系统访问网址:https://aemd-lims.sjtu.edu.cn/
感谢您对AEMD平台的关注!
设备照片:

先进电子材料与器件(AEMD)平台
2025年10月30日